引言
我國國防軍工、農業、醫療等領域的迅猛發展 對材料表面耐磨防護性能的要求日益嚴苛。物理 氣相沉積(Physical Vapor Deposition,PVD)技術是 材料表面改性的常用方法,主要包括真空蒸鍍、濺 射沉積和離子鍍沉積等技術,PVD 具有工藝簡單、節能環保、成膜均勻致密以及可控性強等特點,已 廣泛應用于多個領域[1-2]。磁控濺射技術是一種通 過氣體離子轟擊靶材,使靶材原子或分子沉積在基 材上形成涂層的技術。傳統磁控濺射技術在高端 應用中存在等離子體密度低、離化率不足等問題,限制了涂層性能的提升[3]。
1999 年,瑞典林雪平大學 Kouznetsov 等[4] 針對 傳統磁控濺射技術靶材功率密度受限問題(靶與 等離子體相互作用引起顯著溫升),首次提出了高 功率脈沖磁控濺射(HiPIMS 或 High Power PulsedMagnetron Sputtering,HPPMS)技術。他們將脈沖 電源與磁控濺射 Cu 陰極疊加,不僅實現了金屬離 化率的顯著提升(約 70%),優化了靶材利用率,進 而改善了涂層厚度均勻性。隨后,該團隊報道,當 以金屬離子為主時,即使在距離濺射源 6~10 cm 處 也能檢測到極高的等離子體密度(>1012 cm?3)[5]。 至2005 年,HiPIMS 技術取得了顯著的發展,能夠 產生 1019 m?3 量級的高等離子體密度[6]。2011 年,Anders[7] 將 HiPIMS 定義為一種峰值功率通常超過 時間平均功率兩個數量級的脈沖濺射技術。他們 發現,靶面的平均峰值功率密度可以達到甚至超 過 107 W/m2,涂層性能可以進一步提升。2010 年,日本學者Nakano 等[8] 基于 HiPIMS 裝置,通過在陰 極上施加極性相反的脈沖來研究其對等離子體 穩定性的影響,發現所施加偏壓不足以維持放電,反 而阻礙了等離子體的演化。隨后,多個研究者提出 雙極高功率脈沖磁控濺射(Bipolar High Power Impulse Magnetron Sputtering,BP-HiPIMS或 B-HiPIMS)技術,通過在傳統 HiPIMS 的負脈沖上疊加正脈沖,可以增加濺射金屬離子的運動速度,并增強離子對 電介質涂層的轟擊,從而解決沉積絕緣涂層過程中 難以施加偏壓及離化率弱化的技術難題[9-10]。哈爾 濱工業大學吳厚樸等[11] 提出兩段式雙極性脈沖高 功率脈沖磁控濺射(Double Bipolar Pulse High Power ImpulseMagnetron Sputtering,DBP-HiPIMS)技術,整 個脈沖周期內靶面附近等離子體密度維持在較高 水平,該模式下平均電流相較于傳統 BP-HiPIMS模式提升了47%。
HiPIMS 技術能夠產生高密度等離子體,顯著 提高靶材原子離化率和等離子體密度,制備出具有 較高性能的涂層[12-14]。然而,沉積速率受限成為該 技術發展的主要瓶頸;膜層內應力水平也需進一步 提高。本文主要綜述了高功率脈沖磁控濺射技術 的改進和復合技術發展,包括 HiPIMS 的波形疊加、同步偏壓和外部輔助裝置增強放電技術,及與射頻、直流和電弧等 PVD 技術的復合技術,并對相關技 術 應用進行了簡要闡述。
1、HiPIMS 技術的優勢與局限性
1.1 HiPIMS 技術的核心優勢
與直流磁控濺射相比,HiPIMS 技術因其高離 化率而具有更高的能量。Ferrec 等[15] 采用 DCMS和 HiPIMS技術制備了 Cr 涂層,并對兩種技術下Cr+、Cr2+和 Ar+的離子能量分布函數進行分析,分析 結果如圖 1所示。在 DCMS 放電中,大部分離子 被熱化而集中于較低的能量區間,而 HiPIMS 中的 離子擁有更高的能量,其中 Cr+離子的分布函數達 到 60 eV 左右,遠高于 DCMS 中約 30 eV 的水平。

HiPIMS 技術是通過高能離子轟擊效應,提高 電離通量和原子遷移率,使沉積的涂層組織致密, 表面粗糙度降低,性能得到明顯改善。Bobzin 等[16]對比了采用直流磁控濺射(Direct current magnetronsputtering, DCMS)和 HiPIMS 技 術 沉 積 (Cr, Al)N涂層的組織結構和性能,圖 2 為兩種技術沉積的 涂層截面形貌(a)(c)和表面形貌(b)(d),HiPIMS-(Cr,Al)N 涂層更光滑致密,并抑制了柱狀晶生長,硬度和彈性模量比 DCMS-(Cr,Al)N 涂層高兩倍多,這可歸因于 HiPIMS 等離子體電離度的顯著增加。
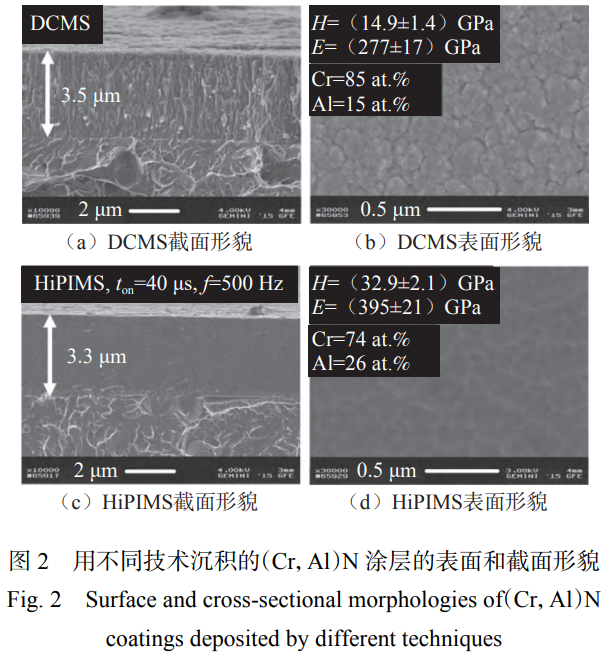
Ying 等[17]研 究 了 HiPIMS 與 射 頻 磁 控 濺 射(RFMS)技術在 WS2 涂層制備上的差異,兩種制備工藝下的涂層表面形貌如圖 3 所示,RF-WS2 涂層 表面呈現出不均勻的蠕蟲狀結構,而 HiPIMS-WS2涂層則為鱗片狀顆粒形態,涂層表面平整光滑,結 構致密。Wang 等[18] 采用 HiPIMS 與電弧離子鍍(Arc IonPlating,AIP) 技術分別制備了 Cr 涂層,研 究發現 HiPIMS-Cr 涂層結構緊湊,表面光滑,幾乎 無宏觀顆粒缺陷,而 AIP-Cr 涂層表面則因弧斑蒸 發效應而布滿較大的宏觀顆粒。這進一步表明HiPIMS 技術在調控涂層微觀結構方面的優越性。Reck 等[19] 通過不同 PVD 沉積技術在 SiO2 和聚苯乙 烯基體上沉積 Ag涂層,結果表明,使用 BP-HiPIMS技術對金屬離子進一步加速所沉積的涂層比 DCMS技術展現出更高的簇密度,兩種工藝下的涂層形態 相似,但 BP-HiPIMS 工藝中涂層結構尺寸(61 nm± 9 nm)比 DCMS 工藝(76nm±8 nm)更小。Cho 等[20]采用 BP-HiPIMS 和 DCMS 技術在 304 不銹鋼表面 制備了 α 相鉭涂層,圖4 為用不同技術所制備涂層 的截面形貌對比,使用雙極 HiPIMS技術形成納米晶涂層,高能鉭離子轟擊導致柱狀晶生長被打斷是 納米晶結構形成的原因。


HiPIMS 技術能夠使等離子體高度離化且無大 顆粒,在高偏壓電場作用下高密度離子束流轟擊基 體表面,使離子注入至基體界面,也可促進涂層局 部外延生長,增強膜/基結合力等性能。Alhafian 等[21]對比了陰極電弧蒸發(Cathodic Arc Evaporation,CAE)與 HiPIMS 技術制備的 TiAlN 涂層,研究發現 HiPIMS誘導涂層晶體結構擇優取向由(200)向(111)轉變,這一轉變歸因于 HiPIMS 脈沖之間的弛豫時 間效應。另外,HiPIMS 技術制備涂層的硬度與應力 水平不一定相關,因而可通過調整沉積參數來調控 楊氏模量
,進而優化 H/E 和 H3/E2 比值來提升涂層耐 磨性。Kiryukhantsev-korneev 等[22] 使用單一 DCMS和HiPIMS 技術在相同功率下制備了(MoTaNbZrHf)- Si-B 涂層,結果表明 HiPIMS 所制備涂層劃痕邊緣 處的涂層剝落面積顯著減小,且壓頭穿透深度達 到 DCMS 涂層的兩倍,此外,涂層磨損率降低約 30%,循環沖擊載荷提高兩倍。在 MAX 相涂層制備領 域,Li 等[23] 使用 HiPIMS 和 DCMS 技術分別在 Ti6Al-4 V合金基底上沉積 Ti-Al-C 涂層,由于具有高 動能的高離子化等離子流,HiPIMS 沉積獲得了納 米晶 TiAlx
化合物,并在 700 ℃ 退火后生成致密平滑的 Ti3AlC2 相涂層,Ti3AlC2 相可以在 450 ℃ 早期 參與結晶,而經退火的 DCMS 涂層僅生成 Ti2AlC相。德國賽利(Ceme Con)公司將基于 HiPIMS 技術的Ferro Con?Plus 工藝成功應用于 AlTiN 基高性能涂 層的商業化生產,該涂層展現出卓越的高溫穩定性,最大服役溫度達 1 100 ℃,車削 Inconel 718 合金時,加工 1 000 m 的切削距離后,AlTiN 涂層刀具磨損 帶寬(140 μm)僅為標準 TiAlN 涂層刀具(280 μm)的 一半,且經企業廣泛應用驗證,在不同應用領域,該涂層的刀具壽命均有顯著提升(提高 50%~80%)。HiPIMS 技術以其低占空比和高功率脈沖特性,顯著提升了靶材電離度和等離子體密度,增強了離 子能量和通量,不僅促進了涂層表面粗糙度的降低 和結構的致密化,還提升了涂層的硬度、耐磨性、耐腐蝕性和高溫穩定性,為極端工況下的材料保護 提 供了有力支持。
1.2 HiPIMS 技術發展的主要局限
盡管研究者們已經對 HiPIMS 技術進行了大 量研究,但在相同的平均功率下,其沉積速率仍然 比 DCMS 低,這一直是制約其廣泛應用的核心挑 戰,并持續成為該領域研究的焦點。目前的研究認 為,造成上述問題的主要原因如下:(1)回吸效應,濺射原子的高度電離顯著增強了離子對靶材的反 向吸引作用,即“回吸”現象,直接導致部分濺射粒 子不能有效脫離靶面而參與沉積,從而降低了沉積 速率[24];(2)產率效應,濺射產率隨離子能量的增加 呈非線性增長,限制了高能量脈沖下濺射效率的進 一步提升[25];(3)物種效應,當工作氣體離子被反向 吸引的靶材離子所替代時,濺射過程的動力學特性 發生變化,影響了濺射產率的穩定性,進而降低了 沉積速率[26];(4)輸運效應,HiPIMS 等離子體中強 烈的軸向電位梯度不僅阻礙了因氣體碰撞電離的 低能金屬離子傳輸到基底,還導致他們在徑向傳 輸過程中的側向損失,進一步降低了沉積效率[27]; (5)氣體稀薄效應,在較長的 HiPIMS 脈沖(>50 μs)條件下,氣體稀薄現象降低了可用于濺射的有效 離子密度,這也是導致沉積速率下降的一個重要因 素[28]。Tiron 等[29] 進行了系統性的對比研究,圖 5 為DCMS 和 HiPIMS 在不同脈沖持續時間下的涂層 沉積速率。所有脈沖時間下HiPIMS 技術的沉積 速率均最低,在超短 HiPIMS 脈沖期間,由于金屬 粒子在高密度等離子體區域停留時間不足且離子 返回概率較低,自濺射模式放電的概率相應降低,導致沉積速率相對較高。自濺射是 HiPIMS的一個基本特征[7],其機制(如圖 6 所示)與依賴氣體 Ar 離 子濺射的傳統磁控濺射不同,HiPIMS 主要依賴靶 材自身返回的離子進行濺射,這一過程高度依賴于 電離效率[7]。


HiPIMS 技術的高能量離子注入會導致所沉積 涂層的殘余應力增加。Tillmann 等[30] 采用不同 工 藝 沉積了 AlCrN 和 AlCrVYN 涂 層 , 研 究 發 現DCMS 樣品的宏觀和微觀殘余應力均明顯低于使 用 HiPIMS工藝的樣品,這歸因于 HiPIMS 沉積過 程中產生的高能離子在沉積過程中加速了原子間 的碰撞與重組,并促進了晶格缺陷(如空位、位錯 等)的形成,進而導致了殘余應力的累積。Patidar等[31] 采用不同工藝沉積 AlN 涂層,并對涂層中的 應力進行了分析,圖 7 為采用不同制備技術得到的AlN 涂層中的 Ar 離子摻雜含量及應力值,所有用HiPIMS 制備的涂層均展現出比用 DCMS 制備的涂 層更高的應力水平和 Ar 離子摻雜含量,當引入基體 偏壓時,用 HiPIMS 沉積的涂層應力和 Ar 離子摻雜 含量均比偏壓為 0 V 時有進一步提高。Cemin 等[32]和 Yang 等[33] 也 報 道 了 類 似 結 果 。 Li 等[34] 采 用HiPIMS 技術沉積了 TiAlSiN 涂層,結果表明,在 0 V到?150 V 的偏壓下,離子轟擊增強導致涂層擇優 取向從(200)向(220)轉變,壓應力從?0.5 GPa 增加 到?1.7 GPa,硬度和韌性在?150 V 時偏壓達到最大 值 37.5 GPa±0.6 GPa 和 H/E = 0.110;當偏壓進一步 增 加 到?200 V 時 , 壓 應 力 進 一 步 增 大 至 ?3 GPa,過度的離子轟擊促使涂層擇優取向轉變為(200),涂層的硬度、韌性和結合強度也有明顯降低。Das 等[35] 采 用 HiPIMS 技 術 沉 積 TiAlSiN 涂 層 的 研究進一步表明,隨著脈沖頻率的增加,雖然沉積 速率有所提升,但涂層表面粗糙度也從 9.42 nm 增 加至 14.32 nm。

HiPIMS 技術雖然取得了顯著的進步,但其較 低的沉積速率一直是限制其廣泛應用的瓶頸。該 問題主要歸因于回吸效應使有效濺射粒子減少,產 率效應限制了高能量下的濺射效率,物種效應影響 了濺射動力學穩定性,輸運效應阻礙了離子向基材 的有效傳輸,以及氣體稀薄效應降低了有效離子密 度。此外,HiPIMS的高能量離子注入使涂層中的 惰性氣體原子含量增加,導致殘余應力增加,影響 涂層性能。HiPIMS 技術對等離子體氣氛要求較高,容易受到多種因素的影響而產生打弧現象,該現象 不僅會影響沉積過程的穩定性和可靠性,還可能對 設 備和靶材造成損害,增加維護成本。
2、HiPIMS 技術發展及復合技術
基于上述 HiPIMS 技術所存在的問題,研究者 們已開展較多針對性研究,這些研究主要聚焦于HiPIMS 技術本身的發展改進和通過復合技術優化 兩個方面。在 HiPIMS 技術的直接改進方面,主要 包括采用波形疊加、實施同步偏壓技術及增加輔 助設備等方法;復合技術分為與磁控濺射和電弧離 子鍍技術的結合應用,其中 HiPIMS 技術與磁控濺 射技術復合沉積包括與直流磁控濺射、射頻磁控 濺射以及中頻磁控濺射的復合。這些改進不僅增 強了 HiPIMS 的放電,還提高了涂層的沉積速率,改 善了涂層性能。
2.1 HiPIMS 技術的發展改進
2.1.1 波形疊加技術
對于 HiPIMS 技術的低沉積速率和高殘余應 力,可以通過以下方式進行改善:(1)放電脈沖參數 調控(脈沖持續時間、重復頻率、峰值電流等),較 短的脈沖時間能夠有效緩解自濺射現象并抑制氣 體稀薄效應[36]。另外,將 HiPIMS 脈沖限制在非常短 的持續時間(<5 μs)內,能夠顯著提升等離子體的電 離度,有效控制金屬離子的反向吸引效應,提升沉積 效率[37]。(2)改變磁控管的磁場強度或形態,能夠直 接影響等離子體鞘層的特性,優化離子傳輸路徑至 基底的過程,進而提升沉積速率和涂層質量[38-39]。(3)以多脈沖模式疊加 HiPIMS,可以提升濺射材料 的電離度并抑制金屬離子的反向吸引效應[40]。通過脈沖來調控 HiPIMS 效果較為常見,圖 8展示了多種脈沖模式的實際應用案例[41]。包括三角 形脈沖[42](圖 8(a))、矩形單脈沖[43](圖 8(b))、脈沖 組內的疊加模式[44](圖 8(c)),此類脈沖組也用于深 度振蕩磁控濺射(Deep Oscillation Magnetron Sputtering,DOMS)[45]。圖8(d)所示脈沖組中的低電流用 于放電的預電離,預電離和其后的 HiPIMS 脈沖都 可以由短脈沖組組成,這也稱為調制脈沖磁控濺射(Modulated Pulsed Magnetron Sputtering,MPPMS)[46]。 圖 8(e)所示的反向電壓疊加應用模式是施加比負 濺射電壓更低的正向電壓[47-48]。利用單個脈沖發 生器同時驅動兩個磁控濺射源的雙極操作模式如 圖 8(f)所示[49],這些脈沖模式為 HiPIMS 技術提供 了全新的研究方向。通過將 HiPIMS技術疊加可 實現波形轉變,進而改善涂層沉積速率,多方面調 控涂層殘余應力及其他性能,并提供良好的等離子 體氛圍,有利于持續穩定地起輝及放電。
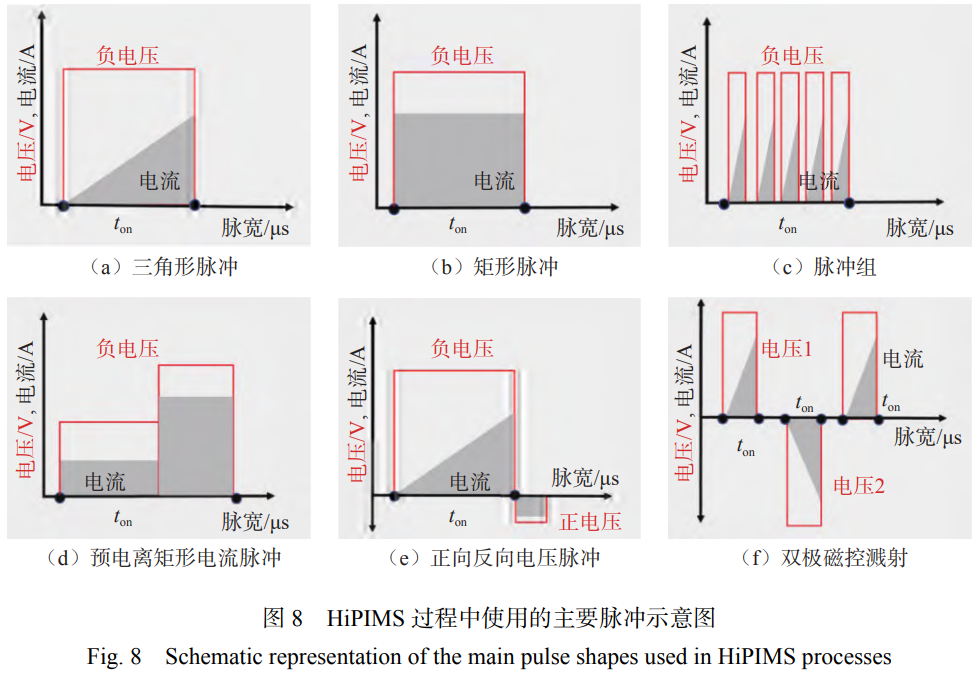
2.1.2 同步偏壓技術
HiPIMS 工作期間,氣體離子電離與放電電流 同步發生,而在靶電流密度達到較高值后金屬離子 才產生,在 HiPIMS 脈沖的后半部分,放電主要以 金屬離子為主,氣體稀薄效應和離子化物質的質量 差都可能導致其到達基體的時間不同,這導致氣體 離子一般在金屬離子之前到達[50-51]。利用同步脈 沖偏壓來實現金屬離子同步 HiPIMS(Metal-IonsSynchronized HiPIMS,MIS-HiPIMS)方法能夠選擇 性地增加特定離子的動能,同時最大限度地減少涂 層中的惰性氣體,拓展了其在半導體領域的應用。
蘭州空間技術物理研究所的 Gui 等[52] 采用 MISHiPIMS技術調控高能離子通量來優化涂層表面的 轟擊效應。研究表明,隨著同步脈沖寬度的增加,沉積的 CrSiN 涂層從粗糙的橫向柱狀結構逐漸演 變為光滑和緊湊的柱狀結構,晶粒細化,硬度和彈 性模量顯著增強,磨損率低至 9.1×10?16 m3/(N·m)。Patidar 等[31] 采用 MIS-HiPIMS 技術改善傾斜角沉 積 AlN 涂層,發現無論沉積角度如何,涂層中柱狀 晶粒的生長幾乎垂直于基體表面,與 HiPIMS 技術 相比,涂層中惰性氣體離子含量降低。另外,將其 與 DCMS 沉積態樣品暴露于大氣環境 5 min 后,DCMS 涂層中約有 5% 的氧含量,而 MIS-HiPIMS涂層僅顯示表面氧化,涂層內部保持無氧狀態。這 歸因于其致密微觀結構 ,防止了涂層的晶界氧化。
2.1.3 輔助設備增強技術
通過引入外部輔助設備,如疊加電子回旋共振 裝置或添加外部磁場,能夠改變離子輸運通量,加 速涂層沉積過程,同時改善涂層質量[53]。早在 20 世 紀 90 年代,電子回旋波共振(Electron Cyclotron WaveResonance,ECWR)輔助磁控濺射技術就有報 道[54-55]。隨后,Stranak 等[56] 驗證了將 HiPIMS 與 RF(fRF=13.56 MHz)-ECWR 等離子體源相結合沉積涂 層的設想,研究發現,ECWR 輔助顯著促進了金屬 離子的產生,在低壓區域,金屬電離通量增加了約30%。Krysová等[57] 采用反應 HiPIMS 結合 ECWR的方法沉積Fe2O3 涂層,展現了高電離度與更多濺 射粒子的特點,ECWR 的輔助將沉積涂層過程中 的最小啟輝氣壓由1 Pa 降低至 0.35 Pa,復合輔助 技術也顯著提高了放電脈沖期間等離子體的電子 溫度與離子密度。微波等離子體輔助 HiPIMS(Microwave Plasma-Assisted, MA-HiPIMS)技術近年來 受到廣泛關注。Hain 等[58] 研究了 HiPIMS 和 MAHiPIMS技術對 DLC 涂層性能的影響,在 HiPIMS模式下,等離子體的最大電勢和電子溫度數值在脈 沖結束時出現,離子和電子密度的峰值略后出現,余輝期間,帶電粒子飛濺向基體,隨后各項參數數 值下降。在 MA-HiPIMS 模式下,前 20 μs 為典型微 波等離子體特性,隨后因微波源產生的等離子體有 效屏蔽了靶電勢激增引起的電場快速變化,避免了 電流峰值產生,等離子體電勢、電子溫度和離子密 度在脈沖結束前達到最小值,而電子密度在脈沖結 束之后下降。盡管 MA-HiPIMS 未顯著提升涂層的 硬度(上限約 30 GPa),但涂層表面更光滑。
高功率脈沖雖能瞬間釋放大量電子,但部分電 子會直接撞擊真空室壁,使能量損失。引入外部磁 場能夠顯著提升高能電子的利用率,有效遏制其向 真空腔壁的逃逸,促進電子與真空室內中性粒子的 頻繁碰撞與離化過程,進而增強等離子體的密度與 活性。此效應不僅能夠加速 HIPIMS 過程中的沉 積速率,還能改善涂層的質量[59-60]。Li 等[61] 通過輔 助陽極和外部電磁線圈來調控真空室內的電場電 勢和陰極磁場分布,形成外部電場磁場同步增強的HiPIMS(External Electric Field and External Magnetic FieldEnhanced Simultaneously the HiPIMS,(E-MF)- HiPIMS),并以此來制備 V 涂層。結果表明當陽極電壓設定為 70 V 時,輔助模式下基體峰值離子電流密 度比單一 HiPIMS 模式增加了 4 倍,且涂層表面更為光滑致密。在相同靶功率條件下,(E-MF)-HiPIMS的沉積速率比傳統 HiPIMS 高約 73%。Tian 等[62]通過磁場增強 HiPIMS 技術沉積了(AlTi)xN1?x 涂 層,涂層的沉積速率和硬度分別從 23.67 nm/min 和23 GPa增加至 25.67 nm/min 和 28 GPa,表面粗糙度 從 8.7 nm 降低至 5.2 nm,進一步驗證了磁場輔助在 優化HiPIMS 技術方面的有效性。
在 HiPIMS 技術中引入外部輔助裝置及(或)添加外部磁場,一定程度上提高了電離效率和等離 子體穩定性,提高了涂層沉積速率與性能。另外,外部磁場的引入進一步提升了電子利用率,減少了 能量損失。但這些方法都存在高成本、高能耗的 特點 ,不利于工業化發展應用。
2.2 HiPIMS 與磁控濺射復合技術
2.2.1 HiPIMS 與直流磁控濺射復合技術
直流磁控濺射(DCMS)技術具有較低的離化 率,較高的沉積速率,而 HiPIMS 技術由于濺射靶 材離化后,一部分離子返回靶面產生自濺射過程,導致到達基體的濺射離子減少,沉積速率較低,將HiPIMS 與 DCMS技術結合可以有效緩解 HiPIMS沉積速率低的問題[63-64]。
HiPIMS/DCMS 共濺射裝置結合 了 DCMS 源 提供的高沉積速率與 HiPIMS 源產生的高能金屬 離子,實現了涂層性能的優化,在保證力學性能的 同時降低殘余應力。Hsu 等[65] 對比了高功率脈沖 和直流磁控共濺射技術沉積的 TiWC 涂層,采用復 合技術制備的 TiWC 涂層致密,硬度高于 30 GPa,與 DCMS 相比,工藝相對能耗降低了 77%。他們 通過該技術制備的 TiAlSiN 涂層在保持硬度高達30 GPa 的同時,將殘余應力控制在 0.5 GPa 以內[66]。Liu 等[67] 通 過 DCMS 和 HiPIMS/DCMS 共濺射在 充 He 條件下沉積了的 Al涂層,結果表明,采用HiPIMS/DCMS 共濺射時,由于濺射的金屬離子能 量高,沉積的金屬顆粒的遷移能力得到增強,晶粒 尺寸增大,位錯環的直徑和密度減小。Dias 等[68]報道了有關 TiAlTaN 涂層的沉積:復合 DCMS/HiPIMS工藝結合了 DCMS 和 HiPIMS 的優點,所沉積 涂層的硬度(40 GPa)與用單一 HiPIMS 工藝(41 GPa)沉積的相當,但在相同條件下,其沉積速率可達 到 HiPIMS 工藝的 2 倍。Ding 等[69] 使用DCMS 和HiPIMS、復合技術在不同的偏置電壓下沉積 Cr 涂 層。結果表明,隨著偏壓的增加,涂層沉積速率的 下降逐漸減慢, 但 在 500 V 偏壓時仍可保持 約100 nm/min 的沉積速率,涂層表面粗糙度隨偏壓增大而增大。Zoita 等[70] 報道,與 DCMS 濺射相比,在相同溫度下用 DCMS/HiPIMS 復合技術制備的TiC 涂層具有更好的結構有序性,電阻率值降低了6%~23%。在 200 ℃ 沉積溫度下,用 DCMS 沉積的 涂層表面粗糙度約為用 DCMS/HiPIMS 技術沉積 涂層的 3 倍。Wu 等[71] 采用 Al-HiPIMS/TiSi-DCMS配置制備了TiAlSiN 涂層,其最大金屬原子比為Al/(Al+Ti)=0.59,Si 原子數含量為 9.4 %,合成了比 傳統濺射技術組成范圍更廣的 NaCl 結構亞穩態過 渡金屬氮化物。Tillmann 等[72] 使用不同技術沉積TiAlN 涂層,DCMS 涂層僅有?1 817.0 MPa 的殘余 壓應力,HiPIMS 放電的高電離導致涂層殘余應力 值高達?5 979.2 MPa,超過單一 DCMS 涂層殘余應 力的 3 倍,而用復合技術制備的涂層的殘余應力低 至?626.4 MPa 左右。類似的低殘余應力現象在其 他文獻中也有報道[73]。
在 HiPIMS/DCMS 工藝中,由于 HiPIMS 離化 率較高,不同靶位配置模式下涂層性能差異較大。Wicher 等[74] 報道,不同靶位配置會對 Ti1-xAlxBy 涂 層產生較大影響,兩種模式下涂層硬度均隨著 Al含量增加而降低,TiB2HiPIMS/AlB2-DCMS 模式下x=0.36 時,硬度達到最大值 43.1 GPa±2.6 GPa,x=0.76時涂層硬度低至 20.0 GPa±1.2 GPa,而 AlB2-HiPIMS/ TiB2-DCMS 涂層硬度最高可達 46.0 GPa±2.5 GPa,即使Al 含量最高(x=0.74)的涂層也具有 32.8 GPa± 1.7 GPa 的硬度值。Greczynski 等[75] 利用 Ti-
HiPIMS/ Si-DCMS 和 Si-HiPIMS/Ti-DCMS 兩種靶材配置模 式下沉積 Ti1?xSixN 涂層。圖 9 為 200 μs 內靶電壓、電流及功率密度的波形變化, HiPIMS 電壓值在 一個波長內呈下降至穩定趨勢,Si-HiPIMS 的電壓在穩定時約為 Ti-HiPIMS 的 3 倍;HiPIMS 電流值 在一個波長內呈先增大后減小趨勢,Ti-HiPIMS 電流密度峰值出現早于 Si-HiPIMS,功率密度呈現相 同趨勢。高離化率的 Ti 源(Ti-HIPIMS)與低離化率的 Si 源(Si-DCMS)易促進第二相 a-SiNx 析出,生 成納米復合結構,獲得高硬度涂層;反之,高離化率的 Si 源(Si-HIPIMS)和低離化率的 Ti 源(Ti-DCMS)組合,傾向于生成 Ti1?xSixN 固溶體,涂層硬度較低。
HiPIMS 與 DCMS 復合技術結合了兩者優勢, 有效緩解了 HiPIMS 中的自濺射現象,增強了涂層 的結晶度與沉積速率,并保持涂層的高硬度。復合 技術雖降低了相對能耗,但粒子離化率及系統的等 離子體密度也有相應損失,且不同靶位配置顯著影 響涂層微觀結構與性能。總體而言,HiPIMS/DCMS復合技術為制備高性能涂層提供了有效途徑,但仍 需平衡兩者來調控對涂層性能的影響機制。

2.2.2 HiPIMS 與射頻磁控濺射復合技術
射頻磁控濺射(RFMS)技術是通過施加高頻電 場(國際上常用的射頻頻率為 13.56 MHz)實現電容 耦合或電感耦合形成等離子體,電子與氣體分子發 生碰撞使氣體分子離化,高能粒子經電場加速轟擊 靶材,使原子或分子被濺射。RFMS 因對靶材的廣 泛適用性及高效的沉積速率而備受矚目,適用于導 體、半導體和絕緣靶材。這是因為射頻電場能夠 在非導電材料中產生感應電流,激活靶材表面的等 離子體,為濺射過程提供了必要的能量與條件。鑒 于 HiPIMS 技術在沉積速率方面存在的局限性,有 研究者提出了采用 HiPIMS與 RFMS 的共沉積策 略,不僅彌補了 HiPIMS 在沉積速率上的不足,還 進一步拓寬了可用靶材的多樣性[76]。
HiPIMS 與 RFMS 共濺射能夠在改善涂層力學 性能的同時,提高 HiPIMS 濺射效率,增大靶功率 密 度,改善沉積速率。 Diyatmika 等[77] 采 用 HiPIMS/RFMS復合技術制備了 Cr-Si-N 涂層,研究發 現,增加RF 靶功率和 HiPIMS 占空比均可提高沉 積速率。另外,涂層硬度和彈性模量隨著 RF 靶功 率的增加和HiPIMS 占空比的減小而增加,最高分 別達到了 31.5 GPa 和 292 GPa。Holtzer 等[78] 通過該 復合沉積技術提高了 a-NbSi 涂層的沉積速率以及 均勻性,涂層的超導臨界轉變溫度(Tc)和電阻率(ρ)均呈現出優異性能。研究還表明,預電離在混合技 術中能夠有效減少電流響應延遲。葉譜生等[79] 結 合 HiPIMS和 RFMS 技術制備出硬度高達 43.65 GPa的納米復合結構 TiB2-Ni 涂層。Lou 等[80] 使用該復 合技術制備 TiCrSiN 涂層,提高了濺射效率,當 RFSi靶功率從 50 W 增加到 150 W 時,由 HiPIMS 供 電的 TiCr靶的峰值功率密度從 1 214 W/cm2 增加 到 1 350 W/cm2。來自靶材和濺射氣體的所有濺射 離子的能量分布尾部向更高能量區域偏移,這可能 是因為鞘層電壓受到等離子體電勢的影響,而等離 子體電勢反過來又受到等離子體生成方式以及相 鄰磁控源產生的等離子體的影響所致。
HiPIMS/RFMS 復合技術融合了 HiPIMS 的高8 真空與低溫 第 31 卷 第 1 期能離子優勢與 RFMS 在非導電靶材上的廣泛適用 性,為氧化物涂層制備提供了有效方法,但 RFMS技術的高成本、涂層的高殘余應力及在復雜結構 基體上難以均勻沉積等缺點也限制了其應用推廣,需綜合考慮其技術挑戰與經濟成本。
2.2.3 HiPIMS 與中頻磁控濺射復合技術
中頻磁控濺射(Medium Frequency Magnetron Sputtering,MFMS)技術一般用兩個并排的濺射靶,也稱為孿生靶,陽極與陰極在兩個孿生靶中交替變 換,通過施加交變電場中和因負電壓在靶面積累的 正電荷,從而抑制打火現象,并完成濺射過程。濺 射電源的工作頻率一般在 10~100 kHz 內,峰值功 率密度低于0.1 kW·cm?2,占空比較高(≥50%),雖 然濺射產物的電離率相對較低,但能實現較高的沉 積速率。此外,還能在反應氣氛(尤其是氧化性氣 氛)中有效沉積涂層,相較于其他方法,顯著減少了“靶中毒”現象,抑制打弧的產生。目前將 HiPIMS與 MFMS 相結合的系統主要分為三種類型,其不 同之處在于電源及其與濺射靶材的連接方式[81]。 第一種采用兩個(或更多)獨立磁控靶位,其中一個 靶位在 MFMS 模式工作,另一個在 HiPIMS 模式下 運行;第二種系統將兩個電源并聯至同一磁控靶位,通過二極管在輸出端實現電流疊加,進而形成單 極 HiPIMS 和 MF 脈沖;第三種也采用雙磁控靶位 交替極性電流供電,通過雙極電壓脈沖交替濺射兩 個靶材,從而清除靶材表面的介電涂層并補償正空 間電荷,以此解決介電涂層磁控濺射沉積過程中陽 極損耗和頻繁打弧的問題。
采用 HiPIMS/MFMS 復合技術沉積涂層能夠 有效解決頻繁打弧現象,提高沉積速率,并改善涂 層性能。Moirangthem 等[82] 的報道表明,與單一HiPIMS 技術相比,用復合技術所制備 WOx 涂層具 有更高的沉積速率和硬度。在相同條件下,使用HiPIMS-MF 技術的涂層沉積速率達到 62.6 nm/min,明顯高于單一HiPIMS 技術的 35.1 nm/min。Chuang等[83] 采用該復合技術制備了電阻率低至 3.41 Ω·cm、沉積速率高達 13.9 nm/min 的富 Ni3+的 NiO 涂層。Lou 等[84] 對比了不同制備技術對 TiN 涂層截面形貌 的影響,結果表明:用 DCMS 制備的涂層呈現出相 對多孔的柱狀結構;用 MFMS 沉積的涂層在亮場 圖像中可見沿柱狀晶粒分布的缺陷;而用 HiPIMS/ MFMS 復合技術制備 的 TiN 涂 層 , 由 于 HiPIMS增強的離子轟擊效應,表現出比單獨使用 HiPIMS或 DCMS 制備的膜更為致密緊湊的微觀結構。Ferreira 等[85] 采用不同方式沉積 Al2O3 涂層,與單獨 使用 HiPIMS 技術相比,MFMS/HiPIMS 的復合可提 升沉積速率,降低涂層內部的壓應力與結晶度。另 外,單一 HiPIMS 沉積的涂層壓應力高達 10 GPa± 1.6 GPa,用復合技術沉積速率大幅提高,應力降低至?4.10 GPa±0.6 GPa。Kment 等[86] 分別采用 HiPIMS和 HiPIMS/MFMS 復合技術在FTO 導電玻璃基體 上沉積了厚度約 30 nm 的 TiO2 阻擋層 , 并使用 循環伏安法測試涂層覆蓋率,兩種方法所制備的沉 積態 TiO2 涂層均致密,但經 450 ℃ 熱處理后,用HiPIMS 技術制備的樣品的峰值電流密度低于無涂 層 FTO 基體,并伴隨峰間分離。原因在于,經退火 處理后,用 HiPIMS 技術制備的 TiO2 涂層結晶度較 低、缺陷較多,涂層覆蓋率較低,導致涂層對電荷 轉移的阻擋性失效。與此相比,用HiPIMS/MFMS復合技術制備的涂層具有較好的結晶性和較少缺 陷,涂層覆蓋率較高,能夠有效阻擋電荷轉移。
將 MFMS 引入到 HiPIMS 放電中,通過不同配 置方式實現 HiPIMS 與 MFMS 的協同作用,有效提 升了涂層的沉積速率,同時降低了內部壓應力,提 高了涂層的熱穩定性和電化學性能,并抑制了靶材 打弧現象。然而,復合系統也面臨技術復雜性與成 本增加的挑戰 ,限制了其應用。
2.3 HiPIMS 與電弧復合技術
電弧離子鍍(AIP)技術具有高電離度和沉積速 率等優點,但是,該技術沉積過程中會產生大量液 滴,使所制備的涂層表面有較多大顆粒,因而有較 高的表面粗糙度。不同的靶材所產生的液滴數量 和尺寸不同,如 VN 的液滴數量遠高于 CrN,這一 缺陷嚴重限制了其在高端涂層制備領域的廣泛應 用。另外,對于一些高純度高熔點或無法蒸發離化 的靶材(Mo 靶、Si 靶和 B 靶等),電弧弧斑放電不 穩定或無法起弧,而在濺射源(HiPIMS)上工作穩 定,能被較好地原子化和離子化。HiPIMS 與電弧 復合可將電弧無法蒸發離化或產生液滴含量高的 靶材應用于 HiPIMS 源,降低涂層表面粗糙度。
采用 HiPIMS/AIP 復合技術沉積涂層時,高密 度等離子體使氣體和金屬電離增強,涂層的表面平 滑度和機械性能提高。Chang 等[87] 將真空電弧蒸 發(Vacuum Arc Evaporation,VAE)與 HiPIMS 技術 結合沉積TiN 涂層,在單一 VAE 模式下,涂層柱狀 晶的平均尺寸為 121 nm,當 HiPIMS 功率增加到 4 kW時,晶粒細化(47.8 nm)。該團隊還報道了用 HiPIMS/ CAE(陰極電弧蒸發)沉積 TiN 的工藝,研究發現,涂層表面宏觀顆粒數量和尺寸與占空比呈正相關,降 低占空比能夠減小涂層中柱狀晶尺寸,增加納米晶 數量,從而引入更多的晶界來抵抗位錯[88],增加離 子轟擊通量可以有效去除涂層生長過程中形成的 松散顆粒。
Singh 等[89] 使用電弧增強 HiPIMS 技術 制備 AlCrN 涂層,其致密的微觀結構有效阻礙了氧 原子向基體方向的擴散,而使涂層具有優異的抗氧 化性。Ding 等[90] 采用 HiPIMS /AIP 復合技術沉積 具有非晶Si3N4 包裹 Cr(Mo)N 納米晶的 Cr-Mo-Si-N納米復合結構涂層,涂層硬度最高可達 26.5 GPa。 歐瑞康巴爾查斯(Oerlikon Balzers)推出的 H13 涂層 技術結合了電弧蒸發、HiPIMS 和電弧增強輝光放電 三重增強電離,實現了對微合金化、摻雜以及層結 構設計的調控,同時保證了經濟高效的生產。H13系列涂層刀具在加工 42CrMo4 零件時展現出卓越 的切削性能,能夠完成多達 2001 個零件的加工。
HiPIMS 技術對等離子體氣氛要求較高,如通 入氧氣時易產生打弧現象,對沉積氧化物影響較大。Geng 等[91] 通過 CAE/HiPIMS 復合技術在不同 O2進氣方式下沉積了 Cr-O/Al-O 涂層,并與用 CAE 制 備的(Cr,Al)2O3 涂層進行了對比,圖 10 為幾種涂 層的表面形貌和截面形貌,其中(a)(d)為復合技術 制備Cr-O/Al-O 涂層(O2 從 HiPIMS 靶材附近通入); (b)(e)為復合技術制備 Cr-O/Al-O 涂層(O2 從CAE靶材附近通入);(c)(f)為電弧蒸發制備(Cr,Al)2O3涂層。采用復合技術制備的 Cr-O/Al-O 涂層表面 缺陷明顯少于用 CAE 制備的(Cr,Al)2O3 涂層。
采用復合技術制備的 Cr-O/Al-O 涂層,如圖 10(a)(b)所示,表面缺陷明顯少于用 CAE 制備的(Cr,Al)2O3,如圖 10(c)所示。另外,由于 HiPIMS 源 Al 靶對 O2 的敏感性較高,當從 CAE 源 Cr 靶附近通入 O2 時,能夠更有效地控制氧氣流量范圍,使涂 層表面顆粒數量減少,同時抑制 HiPIMS 源濺射過 程中的打弧放電。
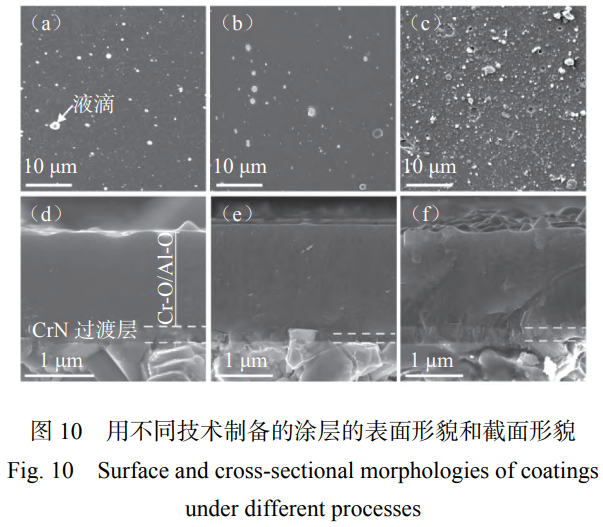
HiPIMS/AIP 復合技術結合了 HiPIMS 的低表 面粗糙度和 AIP 的高沉積速率,可以有效增強氣體 和金屬的電離,減少涂層表面的宏觀顆粒數量和尺 寸,細化晶粒,提高了涂層的機械性能和硬度。此 外,該復合技術還能通過調控氧氣進氣方式來抑 制 HiPIMS 源打弧放電,進一步提升了涂層的質量。 但這種復合技術需平衡濺射與電弧氣壓,并精確控 制各工藝參數以實現最佳性能。
3、HiPIMS 復合技術的應用領域及展望
3.1 在硬質涂層與耐磨材料中的應用
HiPIMS 技術作為一種先進的表面處理技術,憑借其獨特的脈沖放電模式,在硬質涂層領域展現 出了顯著優勢。特別是在現代加工制造業領域,高 性能刀具涂層技術對于提升加工效率、延長刀具 服役壽命及降低生產成本起著至關重要的作用[92-93]。Ganesan 等[94] 采用雙極 HiPIMS 技術在 WC-Co 刀 片上沉積非晶碳膜,并進行切削退火馬氏體時效鋼 試驗,結果表明,與脈寬為 0 μs 的 DCMS 相比,當 脈寬為 150 μs時,在給定的加工時間內,后刀面磨 損量減少了近 50%,刀具的使用壽命增加了近 2 倍。Tillmann 等
[95] 使用 DCMS/HiPIMS 復合技術顯著 提 高了 TiAlSiN 涂 層 刀 具 的 切 削 性 能 , DCMS/HiPIMS-TiAlSiN 涂層刀具的后刀面磨損寬度僅為67 μm 左右,而 DCMS-TiAlSiN 涂層刀具的后刀面 磨 損寬 度 約為 108 μm。 Moirangthem 等[96] 使 用HiPIMS-MFMS 技術在室溫且不施加偏壓條件下沉 積了AlCrNbSiTiBN 涂層,其耐腐蝕性比 AISI 304不銹鋼提高 10.3 倍。近年來,HiPIMS 技術與多種 物理氣相沉積方法的復合應用逐漸受到關注,Tang 等[97] 采用由 RF 和 HiPIMS-MFMS 復合鍍膜 系統沉積的 ZrSiN涂層將 AISI 304 不銹鋼基體的 耐蝕性提高了 8~15 倍。Lu 等[98] 利用 DC、RF 和HiPIMS-MF 復合技術,有效解決了 Ti 靶(HiPIMSMF模式)中毒的問題,并獲得了硬度高達 34.1 GPa,平均摩擦系數低至 0.46的 CrTiBN 涂層。
摩擦系數低至 0.46 的 CrTiBN 涂層。 針對極端服役環境,如高溫、高壓及高腐蝕等 條件,傳統材料的性能往往受限。用 HiPIMS 復合 技術制備高性能的硬質涂層,為耐磨部件在極端環 境下的應用提供了可能[99]。Qin 等[100] 采用 DCMS 和 HiPIMS 復合技術研究了 MoS2-Ti 復合涂層的摩 擦學行為,結果表明,適量 Ti(原子數約 13.5 %)的 摻入顯著提升了涂層的耐磨性,涂層的平均摩擦系 數 低至 0.04。 Zhang等[101] 采 用 DCMS/HiPIMS 復 合技術制備了摩擦系數和磨損率分別低至 0.08 和4.3×10?5 mm3·N?1·m?1 的 VAlN/Ag 多層涂層, Ag 層 表現出納米孿晶結構,經 300 ℃ 的高溫摩擦試驗后,內部相結構保持不變。Gui 等[102] 利用該復合沉積 技術制備的 TiAlCrN 陶瓷涂層硬度 為 28.3 GPa,摩擦試驗中在磨損軌跡處形成的致密界面氧化物 層有效提升了涂層的耐磨性,磨損率低至 8.9× 10?17 m3·N?1·m?1。Lou 等[103] 報道了用 HiPIMS-MFMS復合技術制備 nc-TiC/a-C:H 納米復合涂層的研究,該 涂層具有高硬度、高耐磨性以及優異的耐硫酸腐 蝕性能,成為惡劣環境應用中很有前景的防護涂層。
將 HiPIMS 技術與其他 PVD 技術復合,能夠提 高涂層的耐磨性及耐腐蝕性,提升加工精度與效率,顯著提升工具和零部件的使用壽命,為其在極端環 境下的應用提供前提條件,在高端制造方面應用潛 力巨大。
3.2 在功能涂層與器件領域的應用
HiPIMS 復合技術在光伏器件及與半導體相關 涂層的制備中展現出顯著優勢。Lin 等[104] 采用HiPIMS/DCMS 復合技術在硬質合金上沉積了 HfBx涂層,該涂層具有高達 49.3 GPa±3.6 GPa 的超高硬 度和 667.0 GPa±9.2 GPa 的楊氏模量,可用于航空 航天、熱光伏器件和互補金屬氧化物半導體。擴 散屏障是集成電路中至關重要的組成部分,屏障失 效會導致擴散形成銅硅化物,嚴重影響器件性能和 壽命。
Mühlbacher 等[105] 通過 DCMS/HiPIMS 復合技 術在無加熱條件下制備了 Ti0.84Ta0.16N 阻擋層,900 ℃退火后,Ti0.84Ta0.16N 涂層中僅有輕微的 Cu 擴散現象,滿足半導體行業日益嚴苛的溫度要求。WN 涂層因其硬度高、熱穩定性好、電阻率低等優勢,在半 導體行業中常用作擴散阻擋層、電容器和場效應 晶體管(FET)中的電極防護涂層,Lou 等[106] 使用HiPIMS/MF 復合系統制備的 WN0.12 涂層具有 0.33的低摩擦系數和 31.5 GPa 的高硬度。
在核反應堆領域,核燃料后處理時相關零部件 常處于濃硝酸強腐蝕狀態下。Chabanon 等[107] 在304 L 奧氏體不銹鋼上沉積的 Zr/ZrO2 涂層,在硝酸 介質中浸泡 9 天后,表面無明顯變化,而無涂層樣品 出現晶間腐蝕,表面出現了顆粒和裂紋。Ammendola 等[108] 通過 BP-HiPIMS 技術在 Cr-4 合金上沉積Cr 涂層,主要應用作核反應堆零部件,經 84 天的 高壓釜暴露后,與無涂層的 Cr-4 合金相比,DCMSCr涂層樣品增重減少了 61%,而 HiPIMS-Cr 和 BPHiPIMS-Cr涂層樣品增重分別減少了 80% 和 90%。SiC 已成為輕水反應堆中用于核燃料包殼和管道 箱等核心部件材料, Mouche 等[109] 采 用 HIPIMS/ CAE 復合技術在 SiC 基體上制備 Cr 涂層,先用HiPIMS 沉積 Cr 層,再用 CAE 沉積 Cr 層,顯著改 善了涂層結合力,減少了涂層的開裂和剝落。
汽車行業對涂層的熱機械穩定性要求較高。 中國科學院力學所采用 HiPIMS/AIP 復合技術研制 了 TiCN、CrAlSiN、DLC 等系列三元、四元高硬高 溫涂層,并應用于長春一汽的壓鑄模具、熱鍛模具,使模具的加工壽命提高 3~5 倍以上,尤其是含釔高 溫涂層,實現了 800~1 200 ℃ 環境下涂層在熱鍛模 具上的工程應用。荷蘭豪澤(Hauzer)公司研發的Flexicoat 1500 系統同時配備 HiPIMS、電弧和離子 滲氮等六種沉積技術,最大載重可達 3 000 kg。用 該系統的復合技術制備的涂層用在水龍頭、淋浴 噴頭等衛浴五金件上,能有效減少指紋殘留,保持 五金件表面清潔亮麗,減少清潔維護的頻率;用在 汽車發動機等零部件上,能減少熱傳導,有助于降 低發動機的工作溫度,減少燃油消耗;用在大尺寸 成型模具上,能減少被加工材料在模具表面的黏附,簡化清理過程,提高生產效率,減少模具在生產過 程中的磨損,延長模具壽命,降低更換成本。Carlos等[110] 使用 HiPIMS 和 DC 偏壓技術優化 Nb/Cu 涂 層性能。研究發現,較高的直流電壓可以改善入射 離子通量的方向性,增強吸附原子遷移率,消除涂 層沉積過程中的自陰影效應,制備出表面平滑致密 的涂層,他們認為該技術可應用于射頻超導腔。
HiPIMS 復合技術在功能涂層與器件領域展現 出顯著優勢,能夠有效提升材料表面平滑度和硬度、耐磨性、耐腐蝕性等,廣泛應用于光伏器件及核反 應堆零部件用涂層等領域,在國防軍工等跨學科領 域有較大應用潛力。
3.3 HiPIMS 復合技術展望
隨著環境污染的不斷加劇,環境凈化涂層材料 的研發與應用已成為環保技術領域的重要研究方 向。光催化環境凈化技術是一種利用光催化劑在 光照條件下分解或轉化有害物質的技術,具有綠色、環保、高效節能等優勢。Zinai 等[111] 使用 HiPIMS技術在 Si 基體上制備 TiO2 涂層,并研究了其光學性能,結果表明:與無涂層 Si 基體相比,涂覆 TiO2涂層的 Si 基體在 300~1 200 nm 波長范圍內反射率 顯著下降;無涂層 Si 樣品的紫外線阻擋比例約為40%,而涂覆 TiO2 防護層的 Si 樣品紫外線阻擋比 例約 21%,從而在硅太陽能電池上達到良好的抗反 射和防紫外線效果。Abidi 等[112] 使用 HiPIMS 技術 在滌綸布上制備了CuxO/TiO2 光催化劑涂層,在日 光照射下,該涂層對高濃度的三氯甲烷和丁醛的降 解效率分別達到 90%和 85%,同時具有較高的抑 菌活性。在 80 A 濺射條件下制備的 CuxO/TiO2 光 催化涂層在 2 h 內實現了細菌的完全滅活,可應用 于在室內空氣中凈化紡織品。Ratova 等[113] 采用HiPIMS 技術將 W 元素摻雜在TiO2 涂層中,并通過 亞甲基藍染料的降解率評估其光催化活性,結果表 明,盡管在紫外光照射下未觀察到光催化活性的顯 著提升,但在熒光燈和可見光條件下,該涂層表現 出對亞甲基藍的很強的降解能力,為室內光催化應 用提供了有力支持。在醫療領域,HfO2 涂層常用 作高性能擴展柵場效應晶體管,用于檢測阿爾茨 海默癥等與帕金森相關的 pH 值和蛋白質,目前主 要采用 HiPIMS 技術制備該涂層,未來期望采用HiPIMS 復合技術優化 HfO2 生物傳感器涂層的穩 定性和 pH 檢測中的靈敏度,使該生物傳感器應用 于檢測其他蛋白質型生物標志物,并構建多傳感器 陣列,用于早期篩查患者[114]。在過去的十年中,對 用于生物醫學應用的涂層材料的需求有了巨大的 增長,例如骨科植入物、牙根、心血管支架、心臟 瓣膜和其他外科器械以及藥物緩釋涂層等。目前,HiPIMS 技術已被應用于制備多種生物醫學涂層,包括 DLC、NbO、NiTi 和 TiOxNy 等[115-116],在未來的 技術發展與更新迭代中,利用 HiPIMS 復合技術有 望制備高純度高性能的涂層,在新能源和醫療等跨 學科領域應用中發揮作用。
隨著技術的不斷進步,未來 HiPIMS 復合技術 有望實現更加精細的脈寬控制。通過精確調節脈 沖持續時間,進一步優化等離子體的密度和能量分 布,從而提高涂層的沉積質量和一致性。另外,通 過不同電源的匹配復合系統提高電源的效率和穩 定性 ,從而使 HiPIMS 放電過程更穩定。
4、總結與展望
HiPIMS 技術作為材料表面改性領域的一項關 鍵性創新成果,促進了材料性能提升和新型功能材 料的研發,但其低的沉積速率限制了其發展應用。
為克服其局限性,研究者們采用波形疊加和同步偏 壓等技術對其優化,通過與其他技術的復合和增加 輔助裝置進行不斷改進,均在一定程度上提高了沉 積速率,并改善了涂層性能。未來對于 HiPIMS 復 合技術的進一步研究,應聚焦于通過調控電源模式 及脈沖相關參數來提高 HiPIMS 復合技術的穩定 性,降低成本,解決離化率損失和工藝復雜等難題。 在保證高沉積速率條件下如何有效調控真空室內 等離子體,仍是該技術工業化推廣應用的研究熱點。 另外,未來發展的方向還包括其在特定領域的跨學 科應用,以推動該技術向更高水平發展。
參考文獻:
[1]DAS S,BISWAS S K,KUNDU A,et al. Investigation of mechanical morphological structural and electrochemical properties of PVD TiAlN coating:A detail experimental and its correlation with an analytical approach using the least square method[J]. Applied Surface Science Advances, 2024, 24:100638.
[2]BOBZIN K,KALSCHEUER C,M?BIUS M P. Triboactive CrAlN+MoWS coatings deposited by pulsed arc PVD[J]. Surface and Coatings Technology,2023,475:130178.
[3]吳忠振,朱宗濤,鞏春志,等. 高功率脈沖磁控濺射技術的 發展與研究 [J]. 真空,2009,46(3):18?22.
[4]KOUZNETSOV V,MACáK K,SCHNEIDER J M,et al. A novel pulsed magnetron sputter technique utilizing very high target power densities[J]. Surface and Coatings Technology,1999,122(2/3):290?293.
[5]MACáK K,KOUZNETSOV V,SCHNEIDER J,et al. Ionized sputter deposition using an extremely high plasma density pulsed magnetron discharge[J]. Journal of Vacuum Science and Technology,2000,18(4):1533?1537.
[6]BOHLMARK J, GUDMUNDSSON J T, ALAMI J, et al. Spatial electron density distribution in a high-power pulsed magnetron discharge[J]. IEEE Transactions on Plasma Science,2005,33(2):346?347.
[7]ANDERS A. Discharge physics of high power impulse magnetron sputtering[J]. Surface and Coatings Technology,2011,205:S1?S9.
[8]NAKANO T,MURATA C,BABA S. Effect of the target bias voltage during off-pulse period on the impulse magnetron sputtering[J]. Vacuum,2010,84(12):1368?1371.
[9]KERAUDY J,VILOAN R P B,RAADU M A,et al. Bipolar HiPIMS for tailoring ion energies in thin film deposition[J]. Surface and Coatings Technology,2019,359:433?437.
[10]朱祥瑞,韓明月,馮蓬勃,等. 雙極高功率脈沖磁控濺射技 術薄膜制備研究進展 [J]. 中國表面工程,2022,35(5):10?22.
[11]吳厚樸,田欽文,田修波,等. 新型雙極性高功率脈沖磁控 濺射電源及放電特性研究 [J]. 真空,2019,56(6):1?6.
[12]ZHAO M J,WANG Y T,YAN J H,et al. Dielectric properties of hafnium oxide film prepared by HiPIMS at different O2/Ar ratios and their influences on TFT performance[J]. Journal of Science:Advanced Materials and Devices,2024,9(2):100722.
[13]王啟民,張小波,張世宏,等. 高功率脈沖磁控濺射技術沉 積硬質涂層研究進展 [J]. 廣東工業大學學報, 2013,30(4):1?13.
[14]劉亮亮,周林,唐偉,等. 持續高功率磁控濺射技術高速 制備撓性覆銅板 Cu 膜 [J]. 真空與低溫,2020, 26(5):369?376.
[15]FERREC A,KERAUDY J,JACQ S,et al. Correlation between mass-spectrometer measurements and thin film characteristics using dcMS and HiPIMS discharges[J]. Surface and Coatings Technology,2014,250:52?56.
[16]BOBZIN K,BR?GELMANN T,KRUPPE N C,et al. Influence of dcMS and HPPMS in a dcMS/HPPMS hybrid process on plasma and coating properties[J]. Thin Solid Films,2016,620:188?196.
[17]YING P Y,SUN H Y,ZHANG P,et al. Preparation and tribological properties of WS2 solid lubricating coating with dense structure using HiPIMS[J]. Journal of Materials Research and Technology,2024,32:530?540.
[18]WANG Z,LI W T,WANG Z Y,et al. Comparative study on protective Cr coatings on nuclear fuel cladding Zirlo substrates by AIP and HiPIMS techniques[J]. Ceramics International,2023,49(14):22736?22744.
[19]RECK K A,BULUT Y, XU Z J, et al. Early-stage silver growth during sputter deposition on SiO2 and polystyrene– comparison of biased DC magnetron sputtering,high-power impulse magnetron sputtering (HiPIMS) and bipolar HiPIMS [J]. Applied Surface Science,2024,666:160392.
[20]CHO M G,KANG U,LIM S H,et al. α-phase tantalum film deposition using bipolar high-power impulse magnetron sputtering technique[J]. Thin Solid Films,2023,767:139668.
[21]ALHAFIAN M R,CHEMIN J B,FLEMING Y,et al. Comparison on the structural,mechanical and tribological properties of TiAlN coatings deposited by HiPIMS and Cathodic Arc Evaporation[J].Surface and Coatings Technology,2021, 423:127529.
[22]KIRYUKHANTSEV-KORNEEV P V,CHERTOVA A D,CHUDARIN F I,et al. The structure and properties of highentropy (MoTaNbZrHf)-Si-B coatings deposited by DCMS and HIPIMS methods using the multilayer target[J]. Surface and Coatings Technology,2024,484:130797.
[23]LI Z C,ZHOU G X,WANG Z Y,et al. HiPIMS induced high-purity Ti3AlC2 MAX phase coating at low-temperature of 700 ℃[J]. Journal of the European Ceramic Society,2023,43(11):4673?4683.
[24]KUBART T,FERNANDES D F,NYBERG T. On the description of metal ion return in reactive high power impulse magnetron sputtering[J]. Surface and Coatings Technology,2021,418:127234.
[25]ANDERS A. Deposition rates of high power impulse magnetron sputtering:Physics and economics[J]. Journal of Vacuum Science and Technology A,2010,28(4):783?790.
[26]BAI X B, CAI Q, XIE W H, et al. Effect of ion control strategies on the deposition rate and properties of copper films in bipolar pulse high power impulse magnetron sputtering[J]. Journal of Materials Science,2023,58(3):1243? 1259.
[27]KOZáK T. Particle-based simulation of atom and ion transport in HiPIMS:Effect of the plasma potential distribution on the ionized flux fraction[J]. Plasma Sources Science and Technology,2023,32(3):035007.
[28]KOZáK T,LAZAR J. Gas rarefaction in high power impulse magnetron sputtering:Comparison of a particle simulation and volume-averaged models[J]. Plasma Sources Science and Technology,2018,27(11):115012.
[29]TIRON V,VELICU I L,MIH?IL? I,et al. Deposition rate enhancement in HiPIMS through the control of magnetic field and pulse configuration[J]. Surface and Coatings Technology,2018,337:484?491.
[30]TILLMANN W,ONTRUP F,SCHNEIDER E,et al. Comparative investigation of the structure and mechanical properties of AlCrN and AlCrVYN thin films deposited by dcMS,HiPIMS, and hybrid dcMS/HiPIMS[J]. Hybrid Advances,2024,5:100120.
[31]PATIDAR J,SHARMA A,ZHUK S,et al. Improving the crystallinity and texture of oblique-angle-deposited AlN thin films using reactive synchronized HiPIMS[J]. Surface and Coatings Technology,2023,468:129719.
[32]CEMIN F, ABADIAS G, MINEA T, et al. Tuning high power impulse magnetron sputtering discharge and substratebias conditions to reduce the intrinsic stress of TiN thin films[J]. Thin Solid Films,2019,688:137335.
[33]YANG Y C,CHANG C T,HSIAO Y C,et al. Influence of high power impulse magnetron sputtering pulse parameters on the properties of aluminum nitride coatings[J]. Surface and Coatings Technology,2014,259:219?231.
[34] LI H,LI L H,WANG X T,et al. Effect of bias voltage on the erosion performance of TiAlSiN coatings on TC6 substrate by high power impulse magnetron sputtering[J]. Surface and Coatings Technology,2024,477:130263.
[35] DAS C R,RANGWALA M,GHOSH A. Characteristics of high-power impulse magnetron sputtering (HiPIMS) deposited nanocomposite-TiAlSiN coating under variable pulse frequencies[J]. Vacuum,2024,219:112747.
[36] WANG L,JIN J,ZHU C K,et al. Effects of HiPIMS pulselength on plasma discharge and on the properties of WC-DLC coatings[J]. Applied Surface Science,2019,487:526?538.
[37] TIRON V,VELICU I L,MATEI T,et al. Ultra-short pulse HiPIMS:A strategy to suppress arcing during reactive deposition of SiO2 thin films with enhanced mechanical and optical properties[J]. Coatings,2020,10(7):633.
[38] BRADLEY J W,MISHRA A, KELLY P J. The effect of changing the magnetic field strength on HiPIMS deposition rates[J]. Journal of Physics D: Applied Physics, 2015,48(21):215202.
[39] GHAILANE A,LARHLIMI H,TAMRAOUI Y,et al. The effect of magnetic field configuration on structural and mechanical properties of TiN coatings deposited by HiPIMS and dcMS[J].Surface and Coatings Technology,2020,404:126572.
[40] TIRON V,VELICU I L,VASILOVICI O,et al. Optimization of deposition rate in HiPIMS by controlling the peak target current[J]. Journal of Physics D: Applied Physics,2015,48(49):495204.
[41] VETTER J, SHIMIZU T, KURAPOV D, et al. Industrial application potential of high power impulse magnetron sputtering for wear and corrosion protection coatings[J].Journal of Applied Physics,2023,134:160701.
[42] SERRA R,FERREIRA F,CAVALEIRO A,et al. HiPIMS pulse shape influence on the deposition of diamond-like carbon films[J]. Surface and Coatings Technology,2022,432:128059.
[43] OSKIRKO V O,KOZHEVNIKOV V Y,RABOTKIN S V,et al. Ion current density on the substrate during short-pulse HiPIMS[J]. Plasma Sources Science and Technology,2023, 32(7):075007.
[44]ANTONIN O,TIRON V,COSTIN C,et al. On the HiPIMS benefits of multi-pulse operating mode [J]. Journal of Physics D:Applied Physics,2014,48(1):015202.
[45] LIN J,ZHANG X. Effects of racetrack magnetic field strength on structure and properties of amorphous carbon coatings deposited by HiPIMS using deep oscillation pulses[J]. Surface and Coatings Technology,2022,438:128417.
[46] ELIASSON H,RUDOLPH M,BRENNING N,et al. Modeling of high power impulse magnetron sputtering discharges with graphite target[J]. Plasma Sources Science and Technology,2021,30(11):115017.
[47] LI L H,GU J B,XU Y,et al. Application of positive pulse to extract ions from HiPIMS ionization region[J]. Vacuum,2022,204:111383.
[48] SANTIAGO J A,FERNáNDEZ-MARTíNEZ I,KOZáK T,et al. The influence of positive pulses on HiPIMS deposition of hard DLC coatings[J]. Surface and Coatings Technology,2019,358:43?49.
[49] OSKIRKO V O,ZAKHAROV A N,SEMENOV V A,et al. Short-pulse high-power dual magnetron sputtering[J]. Vacuum,2022,200:111026.
[50] HUO C Q,RAADU M A,LUNDIN D,et al. Gas rarefaction and the time evolution of long high-power impulse magnetron sputtering pulses[J]. Plasma Sources Science and Technology,2012,21(4):045004.
[51] GRECZYNSKI G,ZHIRKOV I,PETROV I,et al. Gas rarefaction effects during high power pulsed magnetron sputtering of groups IVb and VIb transition metals in Ar[J]. Journal of Vacuum Science and Technology A, 2017, 35(6):060601.
[52] GUI B H,HU H J,ZHOU H,et al. Influence of synchronized pulse bias on the microstructure and properties of CrSiN nano-composite ceramic films deposited by MIS-HiPIMS[J]. Ceramics International,2024,50(7):31576?31588.
[53]李春偉,苗紅濤,徐淑艷,等. 復合高功率脈沖磁控濺射技 術的研究進展[J]. 表面技術,2016,45(6):82?90.
[54]葛敏,劉艷梅,李壯,等. N2 流量比對 AlCrMoSiN 涂層組 織結構和性能的影響 [J]. 裝備環境工程,2023,20(3):108?116.
[55] MUSIL J, KADLEC S, MüNZ W D. Unbalanced magnetrons and new sputtering systems with enhanced plasma ionization[J]. Journal of Vacuum Science and Technology,1991,9(3):1171?1177.
[56] STRANAK V,HUBICKA Z,CADA M,et al. Investigationof ionized metal flux in enhanced high power impulse magnetron sputtering discharges[J]. Journal of Applied Physics,2014,115:153301.
[57]KRYSOVá H,CICHO? S,KAPRAN A,et al. Deposition of Fe2O3: Sn semiconducting thin films by reactive pulsed HiPIMS+ ECWR co-sputtering from Fe and Sn targets[J].Journal of Photochemistry and Photobiology A:Chemistry,2024,454:115676.
[58] HAIN C,BROWN D,WELSH A,et al. From pulsed-DCMS and HiPIMS to microwave plasma-assisted sputtering:Their influence on the properties of diamond-like carbon films[J]. Surface and Coatings Technology,2022,432:127928.
[59] LI C W,TIAN X B,GONG C Z,et al. Synergistic enhancement effect between external electric and magnetic fields during high power impulse magnetron sputtering discharge[J].Vacuum,2017,143:119?128.
[60] LI C W,TIAN X B,GONG C Z,et al. The improvement of high power impulse magnetron sputtering performance by an external unbalanced magnetic field[J]. Vacuum,2016,133:98?104.
[61] LI C W,TIAN X B,GONG C Z,et al. Electric and magnetic fields synergistically enhancing high power impulse magnetron sputtering deposition of vanadium coatings[J]. Vacuum,2017,144 :125?134.
[62] TIAN X B,MA Y H,HU J,et al. Microstructure and mechanical properties of (AlTi)xN1-x films by magnetic-field-enhanced high power impulse magnetron sputtering[J]. Journal of Vacuum Science and Technology A,2017,35(2):21402.
[63] HNILICA J, KLEIN P, U?íK M, et al. On direct-current magnetron sputtering at industrial conditions with high ionization fraction of sputtered species[J]. Surface and Coatings Technology,2024,487:131028.
[64]王重陽,劉艷梅,閻兵,等. 調制周期對AlCrSiN/AlCrMoSiN多層膜微結構和性能的影響 [J]. 表面技術,2024,53(15):57?67.
[65] HSU T W,GRECZYNSKI G,BOYD R,et al. Influence of Si content on phase stability and mechanical properties of TiAlSiN films grown by AlSi-HiPIMS/Ti-DCMS co-sputtering [J]. Surface and Coatings Technology, 2021, 427:127661.
[66] HSU T W,GRECZYNSKI G, BOYD R, et al. Dense and hard TiWC protective coatings grown with tungstenion irradiation using WC-HiPIMS/TiC-DCMS co-sputtering technique without external heating[J].Applied Surface Science,2023,618:156639.
[67] LIU Y S,AI X,HUANG J L,et al. The microstructure and mechanical properties of He charged Al films fabricated by HiPIMS/DCMS co-sputtering[J]. Vacuum, 2024, 219:112744.
[68] DIAS N F L,MEIJER A L,BIERMANN D,et al. Structure and mechanical properties of TiAlTaN thin films deposited by dcMS, HiPIMS, and hybrid dcMS/HiPIMS[J]. Surface and Coatings Technology,2024,487:130987.
[69] DING X Y,CUI M H,LIAN Y,et al. Control of the preferential orientation and properties of HiPIMS and DCMS deposited chromium coating based on bias voltage[J]. Vacuum,2024,227:113386.
[70] ZOITA N C,DINU M,KISS A E,et al. A comparative investigation of hetero-epitaxial TiC thin films deposited by magnetron sputtering using either hybrid DCMS/HiPIMS or reactive DCMS process[J]. Applied Surface Science,2021,537:147903.
[71] WU Z T,WANG Q M,PETROV I,et al. Cubic-structure Alrich TiAlSiN thin films grown by hybrid high-power impulse magnetron co-sputtering with synchronized Al+ irradiation[J]. Surface and Coatings Technology,2020,385:125364.
[72] TILLMANN W,GRISALES D,STANGIER D,et al. Influence of the etching processes on the adhesion of TiAlN coatings deposited by DCMS, HiPIMS and hybrid techniques on heat treated AISI H11[J]. Surface and Coatings Technology,2019,378:125075.
[73] TILLMANN W,GRISALES D,TOVAR C M,et al. Tribological behaviour of low carbon-containing TiAlCN coatings deposited by hybrid (DCMS/HiPIMS) technique[J]. Tribology International,2020,151:106528.
[74] WICHER B,PSHYK O V,LI X,et al. Superhard oxidationresistant Ti1-xAlxBy thin films grown by hybrid HiPIMS/ DCMS co-sputtering diboride targets without external substrate heating[J]. Materials and Design,2024,238:112727.
[75] GRECZYNSKI G,PATSCHEIDER J,LU J,et al.Control of Ti1?xSixN nanostructure via tunable metal-ion momentum transfer during HIPIMS/DCMS co-deposition[J]. Surface and Coatings Technology,2015,280:174?184.
[76] JHA S,SINGH V,KUMAR V,et al. Microstructure,wettability,cavitation and corrosion performance of aluminum(Al6061) coated with RF-sputtered AlN thin film[J]. Surface and Coatings Technology,2024,489:131168.
[77] DIYATMIKA W,CHENG C Y,LEE J W. Fabrication of Cr-Si-N coatings using a hybrid high-power impulse and radio-frequency magnetron co-sputtering:The role of Si incor-poration and duty cycle[J]. Surface and Coatings Technology,2020,403:126378.
[78]HOLTZER N,ANTONIN O,MINEA T, et al. Improving HiPIMS deposition rates by hybrid RF/HiPIMS co-sputtering,and its relevance for NbSi films[J]. Surface and Coatings Technology,2014,250:32?36.
[79]葉譜生,王啟民,張騰飛,等. Ni摻雜對 TiB2 硬質涂層組 織結構和力學性能的影響 [J]. 材料保護,2023,56(12):25?35.
[80] LOU B S,YANG Y C,QIU Y X,et al. Hybrid high power impulse and radio frequency magnetron sputtering system for TiCrSiN thin film depositions: Plasma characteristics and film properties[J]. Surface and Coatings Technology,2018,350:762?772.
[81]OSKIRKO V O,ZAKHAROV A N,PAVLOV A P,et al. Hybrid HIPIMS+MFMS power supply for dual magnetron sputtering systems[J]. Vacuum,2020,181:109670.
[82]MOIRANGTHEM I, CHEN S H, LOU B S, et al. Microstructural,mechanical and optical properties of tungsten oxide coatings fabricated using superimposed HiPIMS-MF systems [J]. Surface and Coatings Technology, 2022, 436:128314.
[83] CHUANG T H,WEN C K,CHEN S C,et al. P-type semitransparent conductive NiO films with high deposition rate produced by superimposed high power impulse magnetron sputtering [J]. Ceramics International,2020,46(17):27695? 27701.
[84] LOU B S,ANNALAKSHMI M, SU Y W, et al. Fabrication of TiN coatings using superimposed HiPIMS and MF technique:Effect of target poisoning ratios and MF/HiPIMS pulse on-time ratio[J]. Surface and Coatings Technology,2024,478:130364.
[85] FERREIRA M P,MARTíNEZ-MARTíNEZ D,CHEMIN J B,et al. Tuning the characteristics of Al2O3 thin films using different pulse configurations:Mid-frequency,high-power impulse magnetron sputtering, and their combination[J]. Surface and Coatings Technology,2023,466:129648.
[86]KMENT S,KRYSOVA H,HUBICKA Z, et al. Very thin thermally stable TiO2 blocking layers with enhanced electron transfer for solar cells[J]. Applied Materials Today,2017,9:122-129.
[87]CHANG C L,LO K C,YANG F C,et al. HiPIMS co-sputtering for the increase of the mechanical properties of arc deposited TiN coatings[J]. Journal of Materials Research and Technology,2023,26:2050?2059.
[88]CHANG C L,LUO G J,YANG F C,et al. Effects of duty cycle on microstructure of TiN coatings prepared using CAE/HiPIMS[J]. Vacuum,2021,192:110449.
[89]SINGH A, GHOSH S, ARAVINDAN S. Investigation of oxidation behaviour of AlCrN and AlTiN coatings deposited by arc enhanced HIPIMS technique[J]. Applied Surface Science,2020,508:144812.
[90]DING J C,ZHANG T F,WANG Q M, et al. Microstructure and mechanical properties of the Cr-Mo-Si-N nanocomposite coatings prepared by a hybrid
system of AIP and HiPIMS technologies[J]. Journal of Alloys and Compounds,2018,740:774?783.
[91]GENG D S,XU Y X,WANG Q M. Hybrid deposition of Cr-O/Al-O hard coatings combining cathodic arc evaporation and high power impulse magnetron sputtering[J]. Surface and Coatings Technology,2023,456:129235.
[92]王啟民,彭濱,許雨翔. 面向切削刀具的物理氣相沉積涂 層回顧與展望[J]. 廣東工業大學學報,2023,40(6):12?31.
[93]王鐵鋼,張姣姣,閻兵. 刀具涂層的研究進展及最新制備 技術 [J]. 真空科學與技術學報,2017,37(7):727?738.
[94] GANESAN R,FERNANDEZ-MARTINEZ I,AKHAVAN B,et al. Pulse length selection in bipolar HiPIMS for high deposition rate of smooth,hard amorphous carbon films[J]. Surface and Coatings Technology,2023,454:129199.
[95] TILLMANN W, MEIJER A L, PLATT T, et al. Cutting performance of TiAlN-based thin films in micromilling highspeed steel AISI M3∶2[J]. Manufacturing Letters,2024,40:6?10.
[96] MOIRANGTHEM I,WANG C J,LOU B S,et al. Effects of titanium and boron alloying with non-equimolar AlCrNbSiTi high entropy alloy nitride coatings[J]. Surface and Coatings Technology,2024,482:130709.
[97] TANG Q L,WU Y C,LOU B S,et al. Mechanical property evaluation of ZrSiN films deposited by a hybrid superimposed high power impulse-medium frequency sputtering and RF sputtering system[J]. Surface and Coatings Technology,2019,376:59?67.
[98] LU C Y,DIYATMIKA W,LOU B S,et al. Superimposition of high power impulse and middle frequency magnetron sputtering for fabrication of CrTiBN multicomponent hard coatings [J]. Surface and Coatings Technology, 2018, 350:962?970.
[99]王浪平,孫田瑋. 液態靶材磁控濺射技術研究進展 [J]. 真 空與低溫,2024,30(5):496?503.
[100] QIN X P,KE P L,WANG A Y,et al. Microstructure,mechanical and tribological behaviors of MoS2-Ti composite coatings deposited by a hybrid HIPIMS method[J]. Surface and Coatings Technology,2013,228:275?281.
[101]ZHANG Y P,WANG Z Y,ZHOU S H,et al. Synergistic effect of V and Ag diffusion favored the temperatureadaptive tribological behavior of VAlN/Ag multi-layer coating[J]. Tribology International,2024,192:109285.
[102]GUI B H,ZHOU H,ZHENG J,et al. Microstructure and properties of TiAlCrN ceramic coatings deposited by hybrid HiPIMS/DC magnetron co-sputtering[J]. Ceramics International,2021,47(6):8175?8183.
[103] LOU B S,HSIAO Y T,CHANG L C,et al. The influence of different power supply modes on the microstructure,mechanical,and corrosion properties of nc-TiC/a-C:H nanocomposite coatings[J]. Surface and Coatings Technology,2021,422:127512.
[104]LIN H S,WANG C Y,LAI Z W,et al. Microstructure and mechanical properties of HfBx coatings deposited on cemented carbide substrates by HiPIMS and DCMS[J]. Surface and Coatings Technology,2023,452:129119.
[105] MüHLBACHER M,GRECZYNSKI G,SARTORY B,et al. Enhanced Ti0.84Ta0.16N diffusion barriers ,grown by a hybrid sputtering technique with no substrate heating, between Si(001)wafers and Cu overlayers[J]. Scientific Reports,2018,8(1):5360.
[106]LOU B S,MOIRANGTHEM I,LEE J W. Fabrication of tungsten nitride thin films by superimposed HiPIMS and MF system:Effects of nitrogen flow rate[J]. Surface and Coatings Technology,2020,393:125743.
[107]CHABANON A, SCHLEGEL M L, MICHAU A, et al. Anticorrosion performance of a Zr-based architectured substrate/coating system[J]. Corrosion Science,2023,220:111305.
[108]AMMENDOLA M,ARONSON B,FOURSPRING P,et al. Evaluation of chromium coatings deposited by standard and bipolar high-power impulse magnetron sputtering (HiPIMS & B-HiPIMS) for nuclear power applications[J]. Surface and Coatings Technology,2024,485:130835.
[109] MOUCHE P A,KOYANAGI T,PATEL D,et al. Adhesion,structure, and mechanical properties of Cr HiPIMS and cathodic arc deposited coatings on SiC[J]. Surface and Coatings Technology,2021,410:126939.
[110]CARLOS C P A,LEITH S,ROSAZ G,et al. Planar deposition of Nb thin films by HiPIMS for superconducting radio frequency applications[J]. Vacuum,2024,
227:113354.
[111]ZINAI N,BOUZIDI A,SAOULA N,et al. Tailoring the structural and optical properties of HiPIMS TiO2 thin films for photovoltaic applications[J]. Optical Materials, 2022,131:112590.
[112] ABIDI M,ASSADI A A,BOUZAZA A,et al. Photocatalytic indoor/outdoor air treatment and bacterial inactivation on CuxO/TiO2 prepared by HiPIMS on polyester cloth under low intensity visible light[J]. Applied Catalysis B:Environmental,2019,259:118074.
[113] RATOVA M,WEST G T,KELLY P J. HiPIMS deposition of tungsten-doped titania coatings for photocatalytic applications[J]. Vacuum,2014,102:48?50.
[114] YANG C M,WEI C H,UGHI F,et al. High pH stability and detection of α-synuclein using an EGFET biosensor with an HfO2 gate deposited by high-power pulsed magnetron sputtering[J]. Sensors and Actuators B:Chemical,2024,416:136006.
[115] SHAH R,PAI N,KHANDEKAR R,et al. DLC coatings in biomedical applications-review on current advantages,existing challenges, and future directions[J]. Surface and Coatings Technology,2024,487:131006.
[116] GARG R,GONUGUNTLA S,SK S,et al. Sputtering thin films:Materials,applications,challenges and future directions[J]. Advances in Colloid and Interface Science,2024,330:103203.
無相關信息