引言
物理氣相沉積技術(Physical Vapor Deposition,PVD),具有相對較低的工藝溫度,沉積過程便于控制,制備出的涂層性能優異(均勻性高、殘余應力小)和易于工業化應用等優點,在耐腐蝕涂層、超硬涂層、光學涂層、耐摩擦涂層以及復合多層涂層的制備等領域都得到廣泛的應用[1-6],因此越來越受到研究者的關注[7]。PVD技術主要包括蒸鍍技術、陰極電弧離子鍍技術和磁控濺射技術。其中陰極電弧離子鍍技術具有沉積速率高以及靶材粒子離化率高的優勢,但在加工過程中不可避免地會產生金屬液滴,影響了涂層的致密程度[8]。蒸鍍技術的優勢在于加工成本低,制備出的涂層純度較高,但其缺點在于加工過程中粒子能量較低,制備出的涂層與基體結合較差。相比于以上兩種技術,磁控濺射技術由于其加工過程中粒子能量易于調控,制備出的涂層致密、均勻性高在現代裝備制造業中獲得了廣泛的應用。
近些年來磁控濺射技術發展迅猛,產生了諸如直流磁控濺射(DCMS)、高功率脈沖磁控濺射技術(HiPIMS)等新技術,但涂層沉積速率較低[9-11]制約了磁控濺射規模化應用。例如,采用DCMS技術沉積金屬涂層的速率約為10nm/s[12],對于復合成分涂層,尤其是氧化物涂層,其沉積速率甚至更低[13-15]。由于磁控濺射過程中靶材表面的濺射是產生涂層粒子的主要機制,且濺射強度與放電功率成正比,放電功率受到電源、磁場強度和冷卻系統等設備本身的限制,僅依靠提高放電功率來提升涂層沉積速率,其效果非常有限。
最近的研究表明,當靶材表面[16–22]上發生濺射作用時,還出現了蒸發或升華,涂層的沉積速率可能會顯著增加1~2個數量級。與濺射作用不同,只有在靶材表面溫度極高的情況下,才會出現靶材原子的蒸發或升華。靶材蒸發速率隨著溫度的升高而幾乎呈指數增長,從這個角度看,如果能夠濺射液態靶材,磁控濺射的涂層沉積速率將獲得極大提高。液態靶材磁控濺射技術由Danilin等[23]最早提出,該技術一經報道,就受到國內外學者和工業界的廣泛關注。
由于先進裝備制造業、航空航天、半導體行業對高性能涂層的迫切需求,液態靶材磁控濺射技術具有提高涂層沉積速率以及提升能量利用效率的突出優勢,使其有望成為涂層制備主流技術。國內外學者對液態靶材磁控濺射技術仍處于探索研究階段,因此本文總結國內外近年來對該技術的研究成果,并對該項技術未來的發展趨勢進行討論與展望。
1、液態靶材磁控濺射技術特點及優勢
1.1 液態靶材磁控濺射技術原理
液態靶材磁控濺射放電裝置主要由真空系統、供氣系統、磁控系統、冷卻系統、電源及其調制系統組成,與傳統磁控濺射放電裝置相類似,如圖1所示[24]。但在液態靶材磁控濺射系統中,靶材需要被放置在坩堝中,同時調整坩堝與冷卻系統的間距,使靶材在涂層制備過程中始終保持熔化狀態。在放電開始時,靶材一般是未熔化的,通過調整放電功率,靶材在等離子體轟擊作用下逐漸被加熱至熔化狀態。在靶材熔化后,通過調整放電參數來進行所需涂層的沉積。
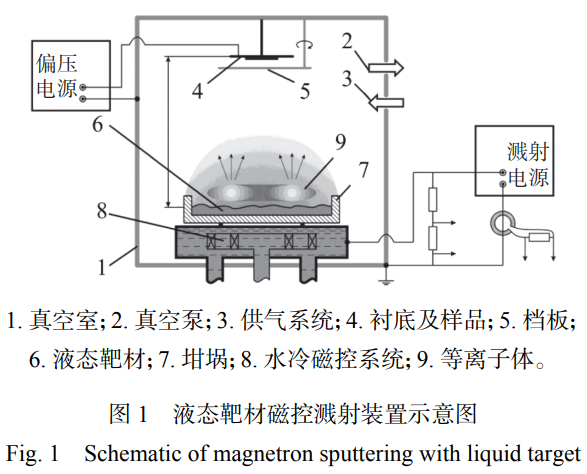
1.2 液態靶材磁控濺射放電伏安特性
研究液態靶材放電(MLT)的伏安特性曲線,對于深入理解放電機制、進一步探索粒子的傳輸機制,對后期在涂層制備過程中具體工藝參數的選擇具有重要的指導意義。關于液態靶材放電特性,目前學界普遍認為是由于高溫下劇烈的熱電子發射導致液態靶材的放電電流顯著增高,放電電壓相比于固態靶材有明顯的降低。
Shapovalov等[25]研究了在純氬氣氛中Ti靶在高溫條件下直流磁控濺射過程的放電特性變化趨勢,如圖2(a)所示,隨著放電電流升高,放電電壓呈現出先增大后減小的趨勢,并且在電流為3A時,放電電壓出現最大值。呈現這種變化趨勢的主要原因是在第一個階段放電電流主要由離子電流(I+)及二次電子電流(γI+)組成,因此放電電壓隨放電電流增高而增大。當電流增大至3A后,由于此前熱量的積累,靶材表面溫度顯著升高,因此熱電子發射十分劇烈并主導了放電過程,熱電子電流(ITe)不斷增大,放電電壓因此降低。圖2(b)給出了放電總電流與離子-二次電子電流之間的變化關系,其中α如式(1)所示:

式中:α為放電總電流與離子-二次電子電流的比值。

可見當放電電流大于3A后,靶表面溫度升高而引發的熱電子發射十分顯著。Shapovalov等[26]還研究了熱Ti靶與冷Ti靶在純氬氣氛中放電伏安特性的異同,如圖3所示。在電流密度j小于75mA/cm2時,二者沒有明顯差異,但當電流密度大于75mA/cm2時,熱Ti靶的放電電壓顯著降低,但冷Ti靶的放電電壓仍然隨電流密度的升高而增大。這說明在強制冷卻條件下的Ti靶熱電子電流發射效應不明顯,只有靶表面處于高溫狀態下才會有劇烈的熱電子發射。

Zhukov等[27]對在純氬氣氛中Al靶從固態到液態的直流磁控濺射放電過程進行了研究,檢測了放電電流、電壓及坩堝溫度隨時間的變化趨勢,如圖4所示,放電過程中直流電源設置為恒功率模式運行。研究結果表明,隨靶材溫度上升,放電電流逐漸增大,放電電壓先增高后降低并在靶材完全熔化后保持穩定。值得注意的是,在靶材完全熔化后,放電電流相比于固態時增大了一倍,這主要是液態靶材蒸發出的金屬原子進一步電離以及熱電子發射的增加所造成的。

1.3 液態靶材磁控濺射放電等離子體特性
涂層沉積速率主要取決于放電等離子體中靶材粒子的密度,因此研究MLT放電過程中的等離子體特性可以為調控涂層的沉積速率及質量提供理論指導,并有助于深入理解液態靶材的放電機理。
Kolodko等[28]利用質譜儀探究了液態Cu靶在直流磁控濺射放電過程中襯底附近的離子通量,檢測結果如圖5所示。結果表明,液態Cu靶在放電過程中,即使沒有工作氣體的參與,也能處于一種獨特的“無氣自濺射”狀態,在等離子體質譜分析中,未檢測到Ar粒子的存在,而固態Cu靶的放電過程則必須依賴于工作氣體粒子(Ar+和Ar2+)的參與。另外,液態Cu靶在“無氣自濺射”放電模式中所展現出的獨特性質,可能會顯著提高所沉積Cu涂層的純度。因為在傳統的固態靶磁控濺射體系中氣體離子和原子會從等離子體中進入到正在沉積的涂層中,影響沉積涂層的純度。Kaziev等[29]對放電等離子體的發射光譜(OES)研究結果同樣證實了這點,如圖6所示,當液態Cu靶處于無氣自濺射放電狀態時,放電等離子體中主要為Cu原子和Cu+離子,工作氣體含量較少。


Tumarkin等[30]的研究證實了在無工作氣體的情況下,液態Cu靶可以僅依靠電離自身蒸發出的原子維持等離子體放電。相比于存在工作氣體的情況下(pAr=1.0Pa),在放電電流密度相同時,液態Cu靶無氣自濺射模式(pAr=0Pa)的放電電壓降低了約10%,如圖7(a)所示,這主要是由于金屬原子比氣體原子的電離電位更低。Tumarkin等[30]還研究了液態Cu靶在脈沖放電條件下(IMLT)等離子體密度和電離度,如圖7(b)所示,等離子體密度和電離度隨放電功率密度增大而逐步增加,電離度在距Cu靶表面5cm處約為60%,呈現出HiPIMS的典型特征。同時還發現,由于液態Cu靶蒸發出的大量金屬原子,使得等離子體強電離區域膨脹,因此增加放電功率會使等離子體密度隨距離增加而變化的梯度減小,在P=2800W/cm2時,等離子體密度與靶表面間距呈線性關系。
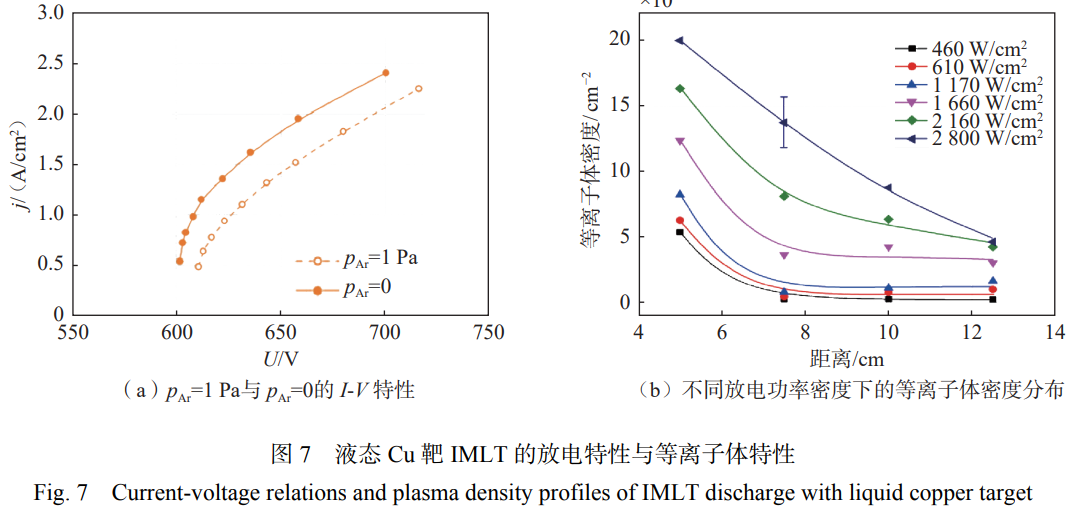
1.4 液態靶材磁控濺射優勢
近年來,對MLT技術的研究表明,其最大的優勢在于能量利用效率高。在沉積純金屬涂層時,相比于固態靶材,由于蒸發和濺射的共同作用,液態靶材的沉積速率可提高10~100倍。Bleykher等[31]研究了Pb靶的放電功率密度與靶表面侵蝕速率的變化趨勢,如圖8所示,當放電功率密度較低時,靶表面溫度較低,濺射是影響靶表面侵蝕速率的主要因素,當靶表面溫度達到熔點的1.65倍后,蒸發導致靶表面侵蝕速率呈指數增加,取代濺射成為影響靶表面侵蝕速率的主要因素。在蒸發占主導地位的情況下,沉積過程粒子流密度由1016atoms/(cm2·s)提升至1018atoms/(cm2·s),涂層沉積速率顯著提高到102~103nm/s,如圖9所示。Bleykher等還計算了Cr靶和Ti靶沉積速率隨放電功率密度的變化趨勢,研究結果表明,在較高的放電功率密度下,熱靶表面蒸發作用十分明顯,與完全冷卻的靶材相比,放置于隔熱鉬坩堝中的Cr靶和Ti靶的沉積速率分別能夠提高20倍和5倍。

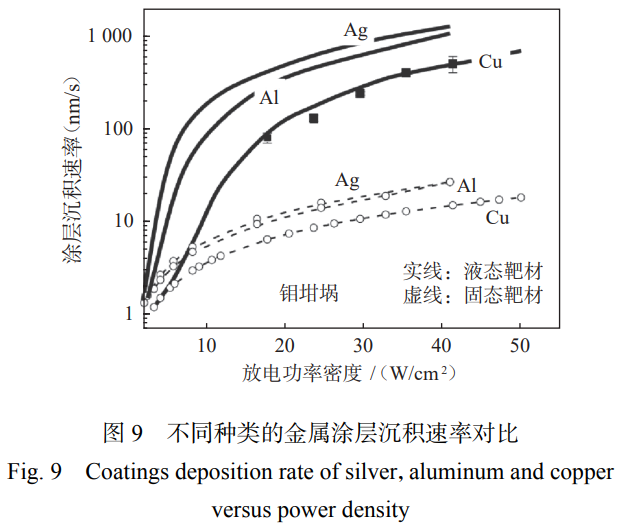
除了具有較高的沉積速率外,液態靶材磁控濺射過程中的等離子體密度與離化率也非常高。較高的離化率便于在濺射過程中調控涂層結構,例如通過向襯底施加偏壓來提高金屬離子向基底方向運動的通量與能量,制備出力學性能較好的涂層。
Tumarkin等[24]在使用液態Cu靶直流磁控濺射技術制備純Cu涂層時,分別向襯底施加了?50V、?100V、?300V、?400V的偏壓,沉積了具有不同結合強度的涂層,沉積涂層的截面形貌如圖10所示。研究發現,通過提高襯底負偏壓,可以將涂層與襯底的結合力大幅提高(襯底偏壓為?400V時,涂層受力達25N時仍未觀察到明顯剝落痕跡)。

2、液態靶材磁控濺射技術在涂層制備中的應用
在傳統的固態靶材磁控濺射過程中,大都需要向真空室內通入工作氣體,并電離工作氣體中的原子用以維持等離子體放電。真空室中工作氣體的壓力的范圍一般為0.1~1Pa[32],濺射出的靶材原子與真空室內的工作氣體原子發生碰撞,降低了靶材原子沉積到基底上的能量,并導致涂層沉積速率的降低。根據前文所述,液態靶材在濺射過程中伴隨著靶材原子的大量蒸發,可以實現無氣自濺射模式。
許多研究者認為,這種模式將為金屬涂層的制備帶來許多優勢[33-37]。目前利用液態靶材無氣自濺射模在Cu、Cr等材料上。
2.1 Cu涂層
Bleykher等[38]采用液態Cu靶磁控濺射制備Cu涂層,制備出的Cu涂層相比于濺射固態Cu靶,結構沒有明顯差異,但沉積速率高達140nm/s(濺射固態Cu靶沉積速率僅為4nm/s),且表面更光滑,平均粗糙度更低,AFM結果如圖11所示,由于蒸發而顯著增加的靶材粒子密度對涂層表面形態產生了影響。Bleykher等[39]還研究了不同坩堝材質對Cu涂層沉積的影響,SEM下Cu涂層的形貌如圖12所示。圖12中,液態Cu靶置于石墨坩堝中沉積得到的涂層(a)表面形貌與(b)截面形貌;液態Cu靶置于鉬坩堝中沉積得到的涂層(c)表面形貌與(d)截面形貌;相比于石墨坩堝,使用鉬坩堝沉積得到的Cu涂層表面顆粒更加細小均勻,涂層也較為致密,而使用石墨坩堝沉積的Cu涂層表面顆粒較為粗大,孔隙和缺陷較多,具有明顯的柱狀結構。作者認為鉬坩堝在濺射過程中具有更高通量的熱輻射,使得基體溫度升高,表面原子流動性增強,形成的涂層更為致密。
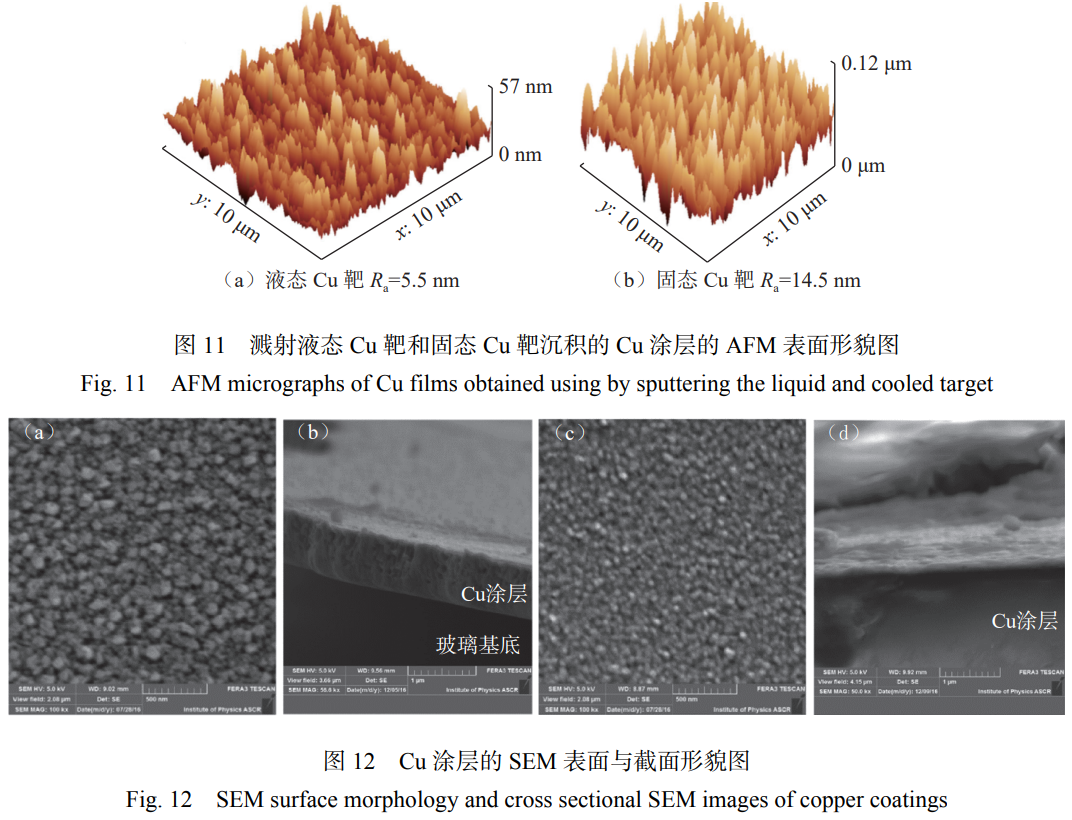
2.2 Cr涂層
Sidelev等[40]通過采用強制冷卻的固態Cr靶和熱Cr靶的磁控濺射技術制備了Cr涂層。研究結果表明,在放電功率密度相同的條件下,熱靶的沉積速率比固態靶高出1.5~2倍,并且涂層的結合力明顯優于固態靶沉積的涂層,劃痕實驗結果如圖13所示。
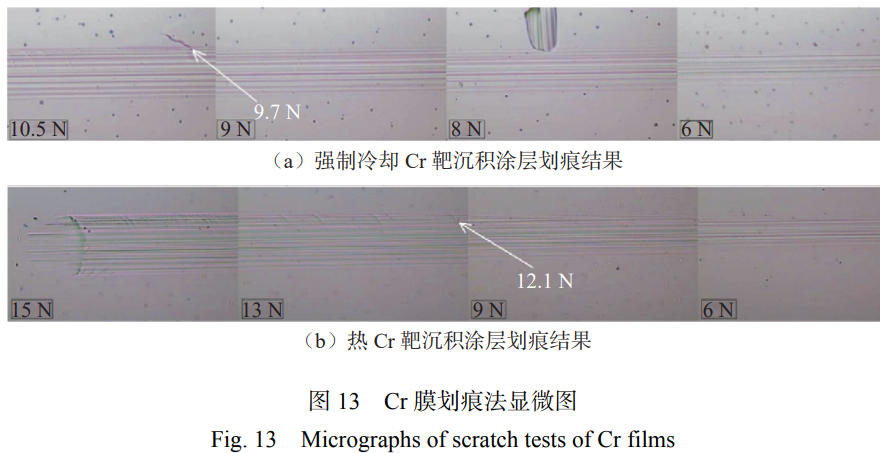
然而,熱靶沉積的涂層硬度相對較低,約比固態靶沉積的涂層低9%(固態靶12GPa降低為熱靶的11GPa)。作者認為主要是由于熱靶在沉積過程中蒸發的大量Cr原子在基體上產生了熱流,導致了硬度的降低并改善了結合力。
3、結語與展望
本文綜述了近年來液態靶材磁控濺射技術(MLT)的研究進展,重點探討了MLT放電過程中的放電特性及等離子體特性,通過對比MLT與傳統固態靶材磁控濺射過程的技術特點,認為MLT技術將磁控濺射和蒸鍍兩種技術的優點進行了融合,從而實現了極高的能量利用效率,并大幅提高了磁控濺射涂層制備過程中的沉積速率,以極高的速率沉積了如Cu、Cr等材質的純金屬涂層。
但與傳統固態靶磁控濺射相比,液態靶材放電等離子體中由蒸發而產生的原子數量較多,其動能相對較低,因此存在著離化率損失與涂層力學性能下降的問題,這也是制約MLT技術發展的重要因素。另外,在濺射過程中液態靶材表面溫度較高,也會向襯底輻射大量熱量導致襯底升溫,因此無法使用MLT技術在對溫度敏感的不耐溫襯底上沉積涂層。由于MLT技術的發展才剛剛起步,現有研究的主要側重點在于研究液態靶材放電特性與提高涂層沉積速率,對上述兩個問題研究較少。因此如何在保證高沉積速率的同時進一步提高放電等離子體中粒子離化率,如何有效利用高溫下靶材表面發射的熱電子,以及如何進一步提高涂層的力學性能,具有重大的研究價值和深遠的研究前景。
參考文獻:
[1]LI C L,WANG L G, SHANG L L, et al. Mechanical andhigh-temperature tribological properties of CrAlN/TiSiNmultilayer coating deposited by PVD[J]. Ceramics International,2021,47(20):29285?29294.
[2]PARK G D,YANG J H,LEE K H,et al. Ultra-high corrosion resistance of Al-Mg-Si film on steel sheet formed byPVD Mg coating and heat treatment[J]. Corrosion Science,2021,192:109829.
[3]KONG D J,FU Y Z,WU Y Z,et al. Interfacial characteristics and tribological properties of TiN coatings prepared by PVD method[J]. Journal of Vacuum Science and technology,2012,32:1078?1083.
[4] ENGELHART W,DREHER W,EIBL O,et al. Deposition ofalumina thin film by dual magnetron sputtering:Is it γ-Al2O3?[J]. Acta Materialia,2011,59(20):7757?7767.
[5]REDDY I N,REDDY V R,SRIDHARA N,et al. Optical and microstructural characterisations of pulsed rf magnetron sputtered alumina thin film[J]. Journal of Materials Science &
Technology,2013,29(10):929?936.
[6]REDDY I N,REDDY V R,SRIDHARA N,et al. Pulsed rf magnetron sputtered alumina thin films[J]. Ceramics International,2014,40(7):9571?9582.
[7]OLSSON M K,MACAK K,GRAF W. Reactive d.c. magnetron sputter deposited Al2O3 films:large-area coatings for industrial applications[J]. Surface and Coatings Technology,
1999,122(2/3):202?207.
[8]LING G W,SHEN H Y,ZHOU F T. Cathode arc deposition technology and its development[J]. Vacuum,1996,1:1?12.
[9]MUSIL J. Recent advances in magnetron sputtering technology[J]. Surface and Coatings Technology,1998,100/101:280?286.
[10]BRAUER G,SZYSZKA B,VERGOHL M, et al. Magnetron sputtering-milestones of 30 years[J]. Vacuum, 2010,84(12):1354?1359.
[11]ANDERS A. Deposition rates of high power impulse magnetron sputtering: Physics and economics[J]. Journal of Vacuum Science & Technology A,2010,28(4):783-790.
[12]JIN Y Z,WU W,LI L. Effect of sputtering power on surface topography of dc magnetron sputtered Ti thin films observed by AFM[J]. Applied Surface Science,2009,255(8):4673?4679.
[13]EDLOU S M,SMAJKIEWICZ A,AL-JUMAILY G A. Optical properties and environmental stability of oxide coatings deposited by reactive sputtering[J]. Applied Optics, 1993,32(28):5601?5605.
[14]ZHUKOV V V,KRIVOBOKOV V P,YANIN S N. Sputtering of the magnetron diode target in the presence of an external ion beam[J]. Technical Physics,2006,51:453?458.
[15]PICHUGIN V F,SURMENEV R A,SHESTERIKOV E V,et al. The preparation of calcium phosphate coatings on titanium and nickel–titanium by rf-magnetron-sputtered deposition:composition,structure and micromechanical properties[J]. Surface and Coatings Technology, 2008, 202(16):3913?3920.
[16]MUSIL J, RAJSKY A, BELL A J, et al. High-rate magnetron sputtering[J]. Journal of Vacuum Science and Technology A,1996,14:2187–2191.
[17]MERCS D,FERRY F,BILLARD A. Hot target sputtering:a new way for high-rate deposition of stoichiometric ceramic films[J]. Surface and Coatings Technology, 2006,201(6):2276?2281.
[18]VLCEK J,ZUSTIN B,REZEK J,et al. Pulsed magnetron sputtering of metallic films using a hot target[C]//52nd Annual Technical Conference Proceedings, Santa Clara, CA:Society of Vacuum Coaters,2009:219-223.
[19]MUSIL J,SATAVA V,BAROCH P. High-rate reactive deposition of transparent SiO2 films containing low amount of Zr from molten magnetron target[J]. Thin Solid Films,2010,519(2):775?777.
[20]TESAR J,MARTAN J,REZEK J. On surface temperatures during high power pulsed magnetron sputtering using a hot target[J]. Surface and Coatings Technology,2011,206(6):1155?1159.
[21]TUMARKIN A V,ZIBROV M,KHODACHENKO G V,et al.High-rate deposition of silicon films in a magnetron discharge with liquid target[J]. Journal of Physics Conference Series,2016,768(1):012015.
[22]TUMARKIN A V,ZIBROV M,KHODACHENKO G V ,et al. Technological features of the thick tin film deposition by with magnetron sputtering form liquid-phase target[J]. Key Engineering Materials,2018,781:8-13.
[23]DANILIN B S,KAKURIN M V,MINAYCHEV V E,et al.Deposition of metal coatings by magnetron sputtering from liquid target[J]. Elektron Tekhnol,1978,2(72):84?87.
[24]TUMARKIN A V,KAZIEV A V,KOLODKO D V,et al. Deposition of copper coatings in a magnetron with liquid target[J]. Physics of Atomic Nuclei, 2015, 78(14): 1674?1676.
[25]SHAPOVALOV V I,AHMEDOV H,KOZIN A A, et al.Simulation of the effect of argon pressure on thermal processes in the sputtering unit of a magnetron with a hot target[J]. Vacuum,2021,192:110421.
[26]SHAPOVALOV V I,ZAVYALOV A V,MELESHKO A A.Current-voltage characteristics of a magnetron with a hot titanium target in chemically active environments[J]. Surface and Coatings Technology,2021,417:127189.
[27]ZHUKOV V V,KOSMIN D M,KRIVOBOKOV V P,et al.Magnetron discharge in the diode with a liquid-metal target[R]. Tomsk, Russia: Nuclear Physics Institute at Tomsk Polytechnic University,2004.
[28] KOLODKO D V,LISENKOV V Y,et al. Cu metallization of Al2O3 ceramic by coating deposition from cooled-andhot-target magnetrons[J]. Coatings,2023,13(2):238.
[29]KAZIEV A V,TUMARKINA A V,LEONOVA K A,et al.Discharge parameters and plasma characterization in a dc magnetron with liquid Cu target[J]. Vacuum, 2018, 156:
48?54.
[30]TUMARKIN A V,KAZIEV A V,KHARKOV M M,et al.High-current impulse magnetron discharge with liquid target[J]. Surface and Coatings Technology,2016,293:42?47.
[31]BLEYKHER G A,KRIVOBOKOV V P,YURJEVA A V,et al. Energy and substance transfer in magnetron sputtering systems with liquid-phase target[J]. Vacuum, 2016, 124:11?17.
[32]MUSSCHOOT J, HAEMERS J. Qualitative model of the magnetron discharge[J]. Vacuum,2009,84(4):488?493.
[33]MUSIL J. Low-pressure magnetron sputtering[J]. Vacuum,1998,50(3/4):363?372.
[34]POSADOWSKI W M. Self-sustained magnetron co-sputtering of Cu and Ni[J]. Thin Solid Films,2004,459(1/2):258?261.
[35]ANDERSSON J,ANDERS A. Gasless sputtering:opportunities for ultraclean metallization, coatings in space, and propulsion[J]. Applied Physics Letters,2008,92:221503.
[36]WIATROWSKI A,POSADOWSKI W M,JOZWIAK G,et al.Standard and self-sustained magnetron sputtering deposited Cu films investigated by means of AFM and XRD[J]. Microelectronics Reliability,2011,51(7):1203?1206.
[37]WIATROWSKI A,POSADOWSKI W M,RADZIMSKI Z J.Pulsed dc self-sustained magnetron sputtering[J]. Journal of Vacuum Science & Technology A,2008,26:1277-1281.
[38]BLEYKHER G A,YURYEVA A V,SHABUNIN A S,et al.The properties of Cu films deposited by high rate magnetron sputtering from a liquid target[J]. Vacuum,2019,169:108914.
[39]BLEYKHER G A,BORDULEV A O,YURYEVA A V,et al.Features of copper coatings growth at high-rate deposition using magnetron sputtering systems with a liquid metal target[J]. Surface and Coatings Technology,2017,324:111?120.
[40]SIDELEV D V,BLEYKHER G A,KRIVOBOKOV V P,et al.High-rate magnetron sputtering with hot target[J]. Surface and Coatings Technology,2016,308:168?173.
相關鏈接